Параметры и корпуса биполярных транзисторов
Добавлено 16 февраля 2018 в 07:56
Сохранить или поделиться
Как и все электрические и электронные компоненты, транзисторы имеют ограничения по напряжению и току, при которых они могут работать без повреждений. Поскольку транзисторы более сложны, чем некоторые другие компоненты, они, как правило, имеют больше видов параметров. Ниже приведено подробное описание некоторых типовых параметров транзисторов.
Рассеиваемая мощность: когда транзистор проводит ток между коллектором и эмиттером, между этими двумя выводами на нем также падает и напряжение. В любой момент времени мощность, рассеиваемая транзистором, равна произведению тока коллектора и напряжения коллектор-эмиттер. Как и резисторы, транзисторы рассчитаны на то, сколько ватт каждый из них может рассеивать спокойно, не получая при этом повреждений. Высокая температура – смертельный враг всех полупроводниковых приборов, а биполярные транзисторы, как правило, более подвержены термическому повреждению, чем большинство из них.
Обратные напряжения: как и диоды, биполярные транзисторы рассчитаны на максимально допустимые напряжения обратного смещения на их PN переходах. Эти параметры включают в себя значения напряжений для перехода эмиттер-база VЭБ, для перехода коллектор-база VКБ, а также напряжение между коллектором и эмиттером VКЭ.
VЭБ, максимальное обратное напряжение между эмиттером и базой, для некоторых слаботочных транзисторов составляет примерно 7 В. Некоторые разработчики схем используют дискретные биполярные транзисторы в качестве стабилизировано на 7 В последовательно с токоограничивающим резистором. Транзисторные входы аналоговых интегральных микросхем также имеют параметр V ЭБ, если превышение которого приведет к повреждению, если использование стабилитронов на входах недопустимо.
Параметр максимального напряжения коллектор-эмиттер VКЭ может считаться максимальным напряжением, которое транзистор может выдержать в режиме полной отсечки (ток базы равен нулю). Этот параметр имеет особое значение при использовании биполярного транзистора в качестве ключа. Типовое значение для слаботочного транзистора составляет от 60 до 80 В. Для силовых транзисторов этот параметр может составлять до 1000 В, например, у транзистора горизонтального отклонения в дисплее на электронно-лучевой трубке.
Ток коллектора: Максимальное значение тока коллектора IК, указываемое производителем в амперах. Типовые значения для слаботочных транзисторов составляют от 10 до 100 мА, для силовых транзисторов – десятки ампер. Имейте в виду, что это максимальное число предполагает состояние насыщения (минимальное падение напряжения между коллектором и эмиттером). Если транзистор не находится в режиме насыщения, и между коллектором и эмиттером падает существенное напряжение, то значение максимальной рассеиваемой мощности будет превышено до достижения максимального значения тока коллектора.
Напряжения насыщения: В идеале транзистор в режиме насыщения действует как замкнутый ключ с контактами на коллекторе и эмиттере, при этом падение напряжения между коллектором и эмиттером равно нулю при максимальном токе коллектора. В реальности этого никогда не бывает. Производители указывают максимальное падение напряжения на транзисторе в режиме насыщения и между коллектором и эмиттером, и между базой и эмиттером (прямое падение напряжения на этом PN переходе). Напряжение коллектор-эмиттер в режиме насыщения, как правило, составляет 0,3 вольта или менее, но это значение, конечно, зависит от конкретного типа транзисторов. Низковольтные транзисторы (с низким V КЭ) показывают более низкие напряжения насыщения. Напряжение насыщения также снижается при увеличении тока базы.
Прямое падение напряжения база-эмиттер, VБЭ, совпадает с аналогичным параметром у диода, ≅ 0,7 В, что не должно удивлять.
Коэффициент бета: Отношение тока коллектора к току базы, β является основным параметром, характеризующим усилительную способность биполярного транзистора. При расчетах схем β обычно постоянной величиной, но, к сожалению, на практике это далеко не так. Таким образом, производители предоставляют набор показателей β (или “hfe“) для определенного транзистора в широком диапазоне рабочих условий, обычно в виде максимальных/минимальных/типовых значений. Вы можете удивиться, увидев, насколько большие отклонения β можно ожидать при нормальных рабочих условия. В спецификации на один популярный слаботочный транзистор, 2N3903, указывается, что коэффициент β может быть в диапазоне от 15 до 150 в зависимости от величины тока коллектора. Как правило, β будет самым высоким при средних токах коллектора и уменьшается для очень низких и очень высоких токах коллектора. h
Коэффициент альфа: Отношение тока коллектора к току эмиттера, α=IК/IЭ. α может быть получен из β, так как α=β/(β+1).
Биполярные транзисторы поставляются в самых разных физических корпусах. Тип корпуса в первую очередь зависит от требуемой рассеиваемой мощности транзистора, так же как и для резисторов: чем больше максимальная рассеиваемая мощность, тем устройство должно быть больше по размеру, чтобы оставаться холодным. На рисунке ниже показано несколько стандартных типов корпусов для трехвыводных полупроводниковых устройств, любой из которых может использоваться для размещения биполярного транзистора. Существует много других полупроводниковых устройств, отличных от биполярных транзисторов, которые тоже имеют три вывода. Следует отметить, что выводы пластиковых транзисторов могут различаться при одном типе корпуса, например, TO-92 на рисунке ниже. Без определения маркировки устройства или проведения электрических тестов невозможно определить назначения выводов у трехвыводного полупроводникового устройства.
Небольшие пластиковые транзисторные корпуса, такие как TO-92, могут рассеивать единицы сотен милливатт. Металлические корпуса, TO-18 и TO-39, могут рассеивать больше мощности, несколько сотен милливатт. Пластиковые корпуса мощных транзисторов, такие как TO-220 и TO-247, рассеивают более 100 ватт, приближаясь к рассеиванию полностью металлического TO-3. Параметры рассеивания, приведенные на рисунке выше, являются максимальными, когда-либо виденными автором у высокомощных устройств. Большинство силовых транзисторов рассчитано на половину или меньше указанной мощности. Для оценки фактических значений смотрите технические описания на конкретные устройства. Полупроводниковый кристалл в пластиковых корпусах TO-220 и TO-247 установлен на теплопроводной металлической пластине, которая переносит тепло от задней части корпуса к металлическому радиатору (не показан). Перед установкой транзистора на радиатор на металл наносится тонкий слой теплопроводящей пасты.
Максимальные значения рассеиваемой мощности из технических описаний на практике достичь трудно. Значение максимальной рассеиваемой мощности основано том, что радиатор поддерживает температуру корпуса транзистора не более, чем 25°C. Но при воздушном охлаждении радиатора это сложно. Допустимая рассеиваемая мощность уменьшается при повышении температуры. Многие технические описания предоставляют графики зависимости рассеиваемой мощности от температуры.
Подведем итоги
- Рассеиваемая мощность: максимально допустимая рассеиваемая мощность на постоянной основе.
- Обратные напряжения: максимально допустимые VКЭ, VКБ, VЭБ.

- Ток коллектора: максимально допустимый ток коллектора.
- Напряжение насыщения – падение напряжения VКЭ в насыщенном (полностью проводящем) транзисторе.
- Коэффициент бета: β=IК/IБ.
- Коэффициента альфа: α = IК/IЭ = β/(β+1).
- Основным фактором, влияющим на рассеиваемую мощность, являются корпуса транзисторов. Большие корпуса рассеивают больше тепла.
Оригинал статьи:
Теги
Биполярный транзисторНапряжение насыщенияОбратное напряжениеОбучениеРассеиваемая мощностьТок коллектораЭлектроникаСохранить или поделиться
7 Предельные режимы работы транзисторов
Лекция 7. Предельные режимы работы транзисторов
Параметры предельных режимов. Предельно допустимые режимы работы транзисторов определяются максимально допустимыми напряжениями и токами, максимальной рассеиваемой мощностью и допустимой температурой корпуса прибора. жс-Все перечисленные параметры предельных режимов обусловлены развитием одного из видов пробоя: по напряжению — лавинного, по току — токового или теплового, по мощности — вызванного достижением максимальной температуры перехода.
жс-Все перечисленные параметры предельных режимов обусловлены развитием одного из видов пробоя: по напряжению — лавинного, по току — токового или теплового, по мощности — вызванного достижением максимальной температуры перехода.
Виды пробоев. Механизмы развития пробоев в транзисторах могут быть различными,
независимо от этого все виды пробоев можно условно разделить на первичные и вторичные. Первичные пробои транзистора отличаются тем, что
Рис 7 1 Вольт-амперные характеристики биполярного транзистора (а) и полевого транзистора (б) при лавинном пробое
они являются обратимыми Если транзистор попадает в режим первичного пробоя, то его нормальная работа нарушается, однако при выходе из режима пробоя его работоспособность восстанавливается Любой вторичный пробой необратим, так как после него происходит деградация транзистора, обусловленная порчен переходов Основными видами первичных пробоев являются лавинный, тепловой и токовый
Лавинный пробой иногда называют электрическим, так как он возникает при высоком значении напряжения обратно смещенного перехода. оо, т е при более высоком напряжении на коллекторе
оо, т е при более высоком напряжении на коллекторе
Это явление объясняется тем, что при отключенной базе внутри транзистора действует положительная обратная связь Заряды, образующиеся в результате лавинного размножения, скапливаются в базе, увеличивая ее заряд. Это вызывает приток неосновных носителей из эмиттера, которые увеличивают ток коллектора Этот процесс нарастает лавинообразно и называется лавинным пробоем с эмит-терным умножением На величину этой положительной обратной связи можно влиять схемным путем Так, например, если подать на эмиттер транзистора запирающее напряжение, то его влияние резко уменьшается и пробивное напряжение увеличивается Такой же эффект можно получить введением в цепь эмиттера сопротивления, так как ток эмиттера, проходя по этому сопротивлению, создает напряжение отрицательной обратной связи и уменьшает действие эмиттера на лавинный процесс
В большинстве применений, особенно для мощных транзисторов, рекомендуют между базой и эмиттером включать небольшое сопротивление rq.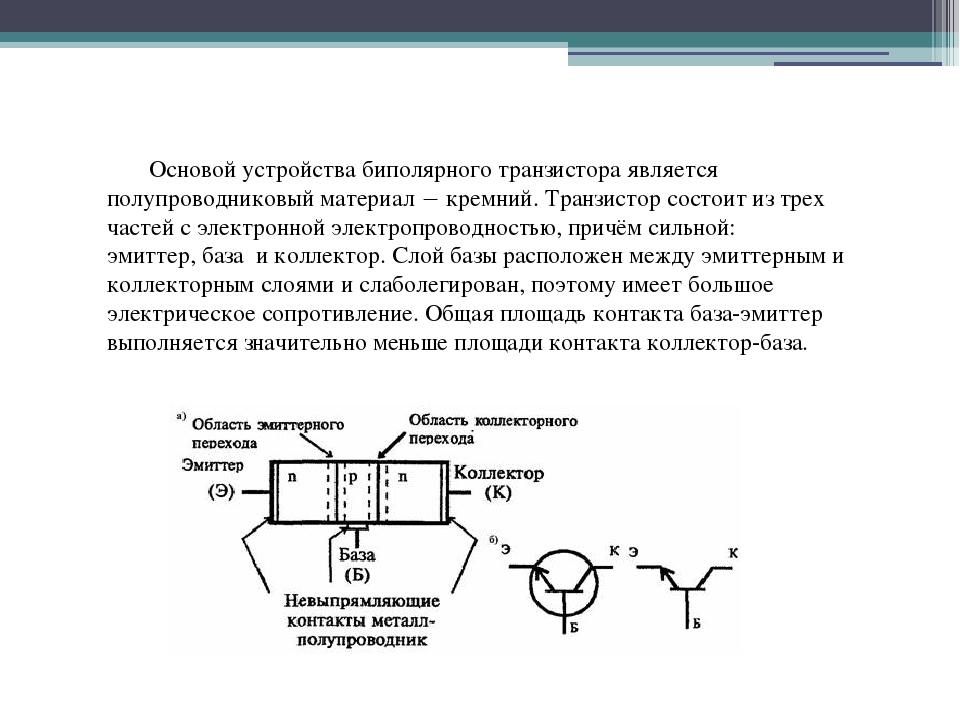 -и-перехода. С ростом температуры перехода возрастают токи утечки и полупроводник переходит в проводящее состояние, а р-п-переход исчезает. Такое явление называют переходом кристаллов в состояние собственной проводимости.
-и-перехода. С ростом температуры перехода возрастают токи утечки и полупроводник переходит в проводящее состояние, а р-п-переход исчезает. Такое явление называют переходом кристаллов в состояние собственной проводимости.
В реальных условиях это явление не всегда ограничивает рост температуры, так как уже при более низких температурах может наблюдаться резкая зависимость от температуры одного или нескольких из основных параметров, например, коэффициента передачи тока или предельного рабочего напряжения.
Рассеяние мощности транзистором имеет место при любом режиме работы, однако оно максимально, когда транзистор находится во включенном состоянии или выключается. При высокой частоте коммутации потери растут пропорционально частоте. С увеличением потребляемой мощности растет и температура транзистора.
Для оценки теплового режима транзистора используют понятие теплового сопротивления, под которым понимают сопротивление элементов транзистора распространению теплового потока от коллекторного перехода к корпусу или в окружающую среду. „ к,
„ к,
• предельно допустимая температура перехода Тпнакс;
• предельная средняя (или импульсная) мощность потерь в транзисторе .Рлотм-чсс;
• предельно допустимая температура корпуса прибора Ткмакс-Температуру корпуса транзистора можно измерять непосредственно. Для этого на мощных приборах может быть указана точка, в которой следует производить это измерение. Непосредственно измерить температуру перехода транзистора в процессе эксплуатации практически невозможно. В связи с этим используют косвенные методы, основанные на температурной зависимости какого-либо параметра. Такие методы обычно не дают возможности определить температуру в наиболее горячих точках структуры, которые возникают из-за разброса электрофизических свойств кристалла или дефектов конструкции Для определения усредненной температуры перехода используют тепловое сопротивление. Эффективная температура перехода в установившемся режиме может быть определена по формулам
С другой стороны, располагая сведениями о максимально допустимой температуре перехода Гц „ако можно определить допустимую мощность потерь в транзисторе
где Гпщке^ОС^С для кремния и 150°С — для германия. см/с — скорость насыщения дрейфа носителей заряда
см/с — скорость насыщения дрейфа носителей заряда
На практике это значение тока никогда не достигается и обычно значение Is. макс определяется возможностью повреждения соединений (перегоранием проводников) внутри транзистора. Значение максимального допустимого тока /к макс обычно указывается в справочных данных транзистора
В ряде случаев максимально допустимый ток транзистора определяется по снижению коэффициента передачи тока ниже определенного значения. Если токо-вый пробой не связан с перегоранием соединительных проводников, то он является обратимым.
Вторичный пробой транзистора возникает или после развития одного из видов первичного пробоя, или непосредственно, минуя развитие первичного пробоя. Непосредственное развитие вторичного пробоя происходит обычно в областисравнительно высоких напряжений на коллекторе и связано с развитием так называемого «токового шнура». При этом коллекторный ток концентрируется в очень малой области коллектора, которая проплавляется и замыкает коллектор с базой. Вторичный пробой происходит при значениях тока и напряжения, меньших гиперболы максимальной мощности (рис 7.3)
Вторичный пробой происходит при значениях тока и напряжения, меньших гиперболы максимальной мощности (рис 7.3)
Если транзистор работает в усилительном режиме, то развитие вторичного пробоя и возникновение токового шнура связано с потерей термической устойчивости, при которой увеличение тока в каком-либо месте структуры приводит к повышению ее температуры, а повышение температуры увеличивает ток Этот процесс нарастает лавинообразно и приводит к проплавлению структуры
Электрический и тепловой механизмы развития вторичного пробоя являются не единственными В реальных транзисторах концентрация тока и развитие вторичного пробоя могут быть результатом наличия дефектов в кристалле, плохого качества пайки и др Но какова бы ни была причина развития вторичного пробоя, результатом его является шнурование тока и локальный перегрев с проплав-лением кристалла
Для развития вторичного пробоя требуется определенное время, которое может составлять 1 ЮОмкс. Это время называют временем задержки развития вторичного пробоя Если время нахождения транзистора в опасном режиме меньше времени развития вторичного пробоя, то вторичный пробой не возникает. Поэтому при коротких длительностях импульсов тока в транзисторе вторичный пробой может и не развиться. Исследования показали, что при развитии вторичного пробоя (во время задержки) в цепи базы могут возникать автоколебания сравнительно высокой частоты, которые могут быть использованы для предсказания опасною значения тока и защиты транзистора.
Поэтому при коротких длительностях импульсов тока в транзисторе вторичный пробой может и не развиться. Исследования показали, что при развитии вторичного пробоя (во время задержки) в цепи базы могут возникать автоколебания сравнительно высокой частоты, которые могут быть использованы для предсказания опасною значения тока и защиты транзистора.
На рис 7 4 показаны вольт-амперные характеристики транзистора при разви
тии вторичного пробоя из различных областей из области усилительною режима (а), области пассивного запирания (б) и области активного запирания (при обратном смещении эмиттерного перехода) (в) Во всех трех случаях при развитии вторичного пробоя происходит резкое увеличение тока коллектора и снижение напряжения на коллекторе, связанное с проплавлением коллекторного перехода
Вторичный пробой отсутствует в полевых транзисторах Так, например, для полевых транзисторов с управляющим /7-й-переходом с увеличением температуры ток
Рис 7 4 Графики развития вторично! о пробоя из области усилительного режима (а), области пассивного запирания (б), и области активного запирания (в)
Рис 7 5 Температурная зависимость тока стока полевого транзистора с р-п-переходом
стока уменьшается, как показано на рис. ) Различают статическую и импульсную ОБР Статическая ОБР (рис. 7 6 я) ограничивается участками то-
) Различают статическую и импульсную ОБР Статическая ОБР (рис. 7 6 я) ограничивается участками то-
кового пробоя (1), теплового пробоя (2), вторичного пробоя (3) и лавинного пробоя (4). При построении ОБР в логарифмическом масштабе все ее участки имеют вид прямых линий.
Импульсная ОБР определяется максимальным импульсным током коллектора Iv. и макс и максимальным импульсным напряжением пробоя С/кэимакс- При малых
Рис 76 Области безопасной рабогы биполярного транзистора в статистическом режиме (л) и импульсном режиме (б) при различных длительностях импульсов тока коллекюра
длительностях импульсов на ней могут отсутствовать участки, обусловленные тепловым пробоем При длительности импульса менее 1 мкс импульсная ОБР имеет только две границы /к и макс и Гришке- При увеличении длительности импульса появляются участки, ограничивающие ОБР за счет развития вторичного пробоя (3) и теплового пробоя (2)
Границы областей безопасной работы транзистора зависят от температуры его корпуса С увеличением температуры корпуса транзистора границы ОБР, обусловленные тепловым пробоем, перемещаются влево Границы ОБР, обусловленные лавинным или вторичным пробоем, практически от температуры не зависят
Защита транзисторов от пробоя. При использовании транзистора необходимо обеспечить нахождение его рабочей точки внутри ОБР без выхода за ее пределы Даже кратковременный выход рабочей точки за пределы соответствующей ОБР влечет за собой попадание транзистора в область пробоя С целью защиты транзистора от возможного пробоя обычно формируют траекторию его переключения при работе в ключевом режиме Для этого к транзистору подключают дополнительные цепи, содержащие резисторы, емкости, диоды и стабилитроны Параметры этих цепей или рассчитывают, или находят экспериментальным путем Некоторые из таких схем приведены на рис 7 7
При использовании транзистора необходимо обеспечить нахождение его рабочей точки внутри ОБР без выхода за ее пределы Даже кратковременный выход рабочей точки за пределы соответствующей ОБР влечет за собой попадание транзистора в область пробоя С целью защиты транзистора от возможного пробоя обычно формируют траекторию его переключения при работе в ключевом режиме Для этого к транзистору подключают дополнительные цепи, содержащие резисторы, емкости, диоды и стабилитроны Параметры этих цепей или рассчитывают, или находят экспериментальным путем Некоторые из таких схем приведены на рис 7 7
! Простейшая цепь, используемая при индуктивной нагрузке транзистора, j состоит из последовательно соединенных элементов R и С, как показано на j рис 7 7 а Эта цепь работает следующим образом При запирании транзистора
(с индуктивной нагрузкой ток в индуктивности, не меняя своего значения и направления, поступает в 7?С-цепь и заряжает конденсатор С При этом часть энергии запасенной в индуктивности, будет израсходована в резисторе Л.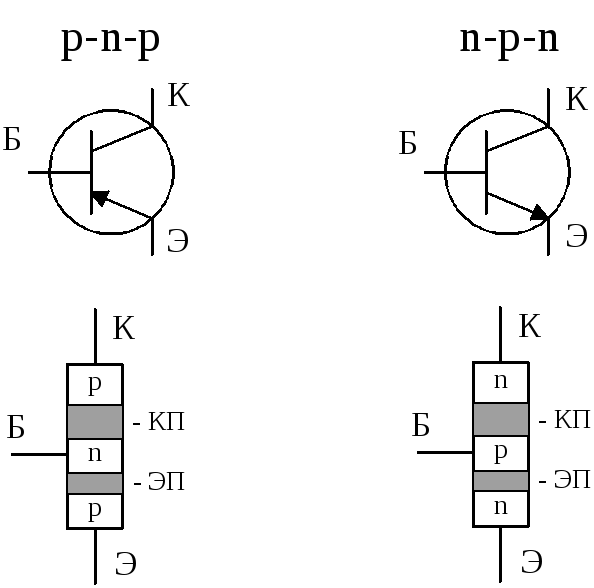 и максимально допустимым напряжением коллектор-эмиттер, определяемым по соответствующей ОБР
и максимально допустимым напряжением коллектор-эмиттер, определяемым по соответствующей ОБР
Вместо 7?С-цепи можно использовать диодно-резистивную цепь, представленную на рис 7.76. В этой схеме при запирании транзистора отпирается диод D, и через него проходит ток индуктивной нагрузки. Для снижения амплитуды импульса тока в диоде последовательно с ним иногда включается сопротивление R Перепад напряжения на транзисторе равен прямому падению напряжения на диоде, т. е. практически отсутствует.
Для ограничения выброса напряжения на коллекторе транзистора при его запирании можно использовать ограничитель на стабилитроне D, как показано на рис. 7.7 в. Все рассмотренные цепи ограничивают предельное напряжение на транзисторе и тем самым предохраняют транзистор от попадания в режим лавинного пробоя.
Для защиты транзистора от перегрева и связанного с этим теплового пробоя применяют охладители, к которым крепится корпус транзистора.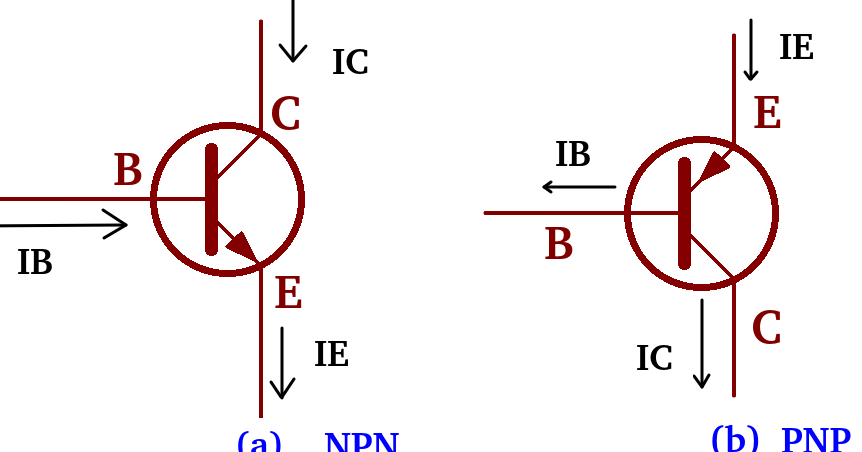 Применение
Применение
охладителей позволяет уменьшить перегрев транзистора.
7 Расцвет Афинской демократии – лекция, которая пользуется популярностью у тех, кто читал эту лекцию.
Наиболее сложной проблемой является защита транзисторов от вторичного пробоя. При развитии вторичного пробоя транзистор теряет управление по базе, и даже подавая на базу обратное смещение, запереть его нельзя. Единственным способом защиты транзистора в этом случае является распознавание развития вторичного пробоя во время задержки и шунтиро-вание выводов коллектор-эмиттер транзистора с помощью быстродействующего тиристора.
Упрощенная схема защиты транзистора от вторичного пробоя приведена на рис 7.8. Схема содержит устройство управления тиристором D защиты, который шунтирует транзистор Т при появлении в его базе колебаний, предшесгвую-ших развитию вторичного пробоя
Рис 7 8 Защита транзистора от вторичного пробоя
Раздел 2 АНАЛОГОВЫЕ ИНТЕГРАЛЬНЫЕ МИКРОСХЕМЫ
Биполярные транзисторы – презентация онлайн
БИПОЛЯРНЫЕТРАНЗИСТОРЫ
2.
 Введение В 1948г. американские ученые Дж.Бардин и В.Браттейн создали
Введение В 1948г. американские ученые Дж.Бардин и В.Браттейн создалиполупроводниковый триод, или транзистор. Это событие имело громадное
значение для развития полупроводниковой электроники. Транзисторы могут
работать при значительно меньших напряжениях, чем ламповые триоды, и не
являются простыми заменителями последних: их можно использовать не
только для усиления и генерации переменного тока, но и в качестве ключевых
элементов. Определение «биполярный» указывает на то, что работа
транзистора связана с процессами, в которых принимают участие носители
заряда двух сортов (электроны и дырки). Слово «транзистор» произошло от
английского словосочетания «transfer resistor» – преобразователь
сопротивления.
Появление первых образцов биполярных транзисторов стимулировало
проведение исследовательских и опытно-конструкторских работ по созданию
различных типов таких приборов во многих странах мира, в том числе и в
Советском Союзе, ученые которого внесли существенный вклад в разработку
этой проблемы.
 В настоящее время биполярный транзистор является одним
В настоящее время биполярный транзистор является однимиз наиболее важных полупроводниковых приборов. Он используется в
радиоэлектронике в качестве дискретного активного элемента, а в планарном
исполнении является основой для создания интегральных твердотельных
схем. В свою очередь, твердотельные схемы являются главными элементами
современного поколения ЭВМ и других сложных радиоэлектронных устройств.
3. Общие сведения
Биполярный транзистор представляет собой полупроводниковый прибор, состоящий из трёхобластей с чередующимися типами электропроводности, пригодный для усиления мощности.
Эти области разделяются электронно-дырочными переходами(э-д переходами). Особенность
транзистора состоит в том, что между его э-д переходами существует взаимодействие – ток
одного из электродов может управлять током другого. Такое управление возможно, потому что
находящегося под обратным напряжением, и изменить его ток.

Каждый из переходов транзистора можно включить либо в прямом, либо в обратном
направлении. В зависимиости от этого различают три режима работы транзистора:
1.Режим отсечки – оба э-д перехода закрыты, при этом через транзистор обычно идёт
сравнительно небольшой ток;
2.Режим насыщения – оба э-д перехода открыты;
3.Активный режим – один из э-д переходов открыт, а другой закрыт.
В режиме отсечки и режиме насыщения управление транзистором почти отсутствует. В
активном режиме такое управление осуществляется наиболее эффективно, причём
транзистор может выполнять функции активного элемента электрической схемы.
Область транзистора, расположннная между переходами называется базой(Б). Примыкающие
к базе оласти чаще всего делают неодинаковыми. Одну из них изготовляют так, чтобы из неё
наиболее эффективно происходила инжекция в базу, а другую – так, чтобы соответствующий
переход наиличшим образом осуществлял экстракцию инжектированных носителей из базы.

Область транзистора, основным назначением которой является инжекция носителей в базу,
называют эмиттером(Э), а соответствующий переход эмиттерным.
Область, основным назначением которой является экстракцией носителей из базы коллектор(К), а переход коллекторным.
Если на Э переходе напряжение прямое, а на К переходе обратное, то включение транзистора
считают нормальным, при противоположной полярности – инверсным.
Основные характеристики транзистора определяются в первую очередь процессами,
происходящими в базе. В зависимости от распределения примесей в базе может
присутствовать или отсутстввать электрическое поле. Если при отсутствии токов в базе
существует электрическое поле, которое способствует вижению неосновных носителей заряда
от Э к К, то транзистор называют дрейфовым, усли же поле в базе отсутствует бездрейфовый(диффузионный).
Принцип работы транзистора
Когда ключ разомкнут, ток в цепи эмиттера(далее Э) отсутствует. При этом в цепи коллектора(К)
имеется небольшой ток, называемый обратным током К и обозначаемый Iкбо. Этот ток очень
мал,так как при обратном смещении К перехода потенциальный барьер велик и непреодолим
для основных носителей- дырок коллектора и свободных электронов базы. К легирован
примесью значительно сильнее, чем база. Вследствие этого неосновных носителей в
коллекторе значительно меньше, чем в базе, и обратный ток К создаётся главным образом
неосновными носителями: дырками, генерируемыми в базе в результате тепловых колебаний,
и электронами, генерируемыми в К.
Замыкание ключа в цепи Э приводит к появлению тока в этой цепи, так как смещение
эмиттерного p-n перехода в прямом направлении понижает потенциальный барьер для дырок,
переходящих из Э в Б, и для электронов переходящих иэ Б в Э. Мы рассматриваем только дырки
так как только они создают пририщение коллекторного тока. Говорят что дырки инжектируются в
базу.
В базе обыкновенного транзистора электрическое поле отсутствует, поэтому дальнейшее
движение инжектированых дырок определяется проецессом диффузии. Так как толщина базы
транзистора много меньше длины свободного пробега дырки до рекомбинации, то большая часть
инжектированных дырок достигает коллекторного перехода, благодаря чему коллекторный ток
усиливается. Лишь очень небольшая часть дырок рекомбинирует с электронами базы. Таким
образом величина тока через правый р-n переход практически полностью определяется
величиной тока через левый переход.
Характерной особенностью рассматриваемых транзисторов является существование двух типов
носителей заряда(электронов и дырок), участвующих в работе прибора. В связи с этим
полупроводниковые проиборы этого получили название биполярных транзисторов.
Семейство выходных характеристик транзистора показано при некоторых постоянных значениях
Э тока:
Для рассматриваемого p-n-p транзистора принято отрицательное напряжение К-Б откладывать
вправо по оси абцисс.
Выходные характеристики, соответствующие отрицательным значениям напряжения К-Б, в правом
верхнем квадранте идут почти горизонтально, но с небольшим подъёмом. Чтобы объяснить это
рассмотрим потенциальную диаграмму транзистора(цветом выделены обеднённые слои):
Так как Э и К сильнее легированы примесью, чем база то обеднённые слои
сосредоточены в основном в базе.
Эффективная толщина базы Wэф, т.е расстояние между границами обеднённых слоёв,
меньше толщины базы W. Увеличение отрицательного напряжения на коллекторе
расширяет обеднённый слой коллекторного перехода и, следовательно, вызывает
уменьшение эффективной толщины базы.
Это явление носит название эффекта Эрли. Модуляция толщины базы объясняет
некоторый подъём выходных характеристик при увеличении отрицательного напряжения
К-Б. Коллекторный ток при этом увеличивается так как меньшая часть дырок теряется в
базе вследствие рекомбинации с электронами.
8. Принцип действия транзистора в качестве усилителя
Транзистор – это полупроводниковый прибор, имеющий двар-n-перехода,расположенных в одном полупроводниковом
монокристалле на расстоянии, значительно меньшем
диффузионной длины неосновных носителей заряда. На рис.
1 показано включение транзистора типа р-п-р по схеме с
общей базой.
Левый р-п-переход называется эмиттерным переходом, а его р-область – эмиттером. Правый р-n-переход
называется коллекторным переходом, а его p-область – коллектором. Заключенная между эмиттером и
коллектором n-область называется базой транзистора. Транзистор, у которого эмиттер и коллектор n-типа, а
база p-типа, называется транзистором n-p-n-типа. При работе транзистора p-n-p-типа в режиме усиления
эмиттерный переход включен в пропускном направлении и инжектирует дырки в базу, откуда они попадают в
цепь обратносмещенного коллекторного перехода. Поскольку толщина базы транзистора W значительно
меньше диффузионной длины дырок Lp, то концентрация инжектированных эмиттером дырок при пролете
через базу почти не изменяется. Таким образом, сила дырочного тока в коллекторной цепи Iрк
приблизительно равна силе дырочного тока в эмиттерной цепи Ipэ. Ток насыщения коллекторного перехода
мал, и им можно в первом приближении пренебречь по сравнению с Ipк. Поскольку коллекторный переход
смещен в обратном направлении, то его сопротивление велико, что позволяет включать в коллекторную цепь
большое сопротивление нагрузки Rн без заметного изменения коллекторного тока. При этом, конечно, Rн
должно быть значительно меньше сопротивления коллектора. В связи с отмеченными выше
обстоятельствами относительно малое изменение падения напряжения на эмиттером переходе,
сопротивление которого мало, вызовет большое изменение падения напряжения на сопротивлении нагрузки (
V = Ipк * Rн ) при почти одинаковом изменении силы тока в эмиттерной и коллекторной цепях. В результате
резкого различия входного и выходного сопротивлений транзистор осуществляет усиление по мощности.
При работе транзистора в описанном выше режиме через эмиттерный переход будет течь и
электронный ток, вызванный инжекцией электронов из базы в эмиттер, но эта составляющая
тока в коллекторный переход не попадает и не влияет на силу тока в его цепи, то есть она
оказывается бесполезной для управления коллекторным переходом. Отсюда следует, что
наилучшее управление коллекторного тока эмиттерным может быть достигнуто , в
транзисторе, в котором эмиттерный ток в основном обусловлен инжекцией дырок в базу. Это
условие выполняется за счет того, что обычно удельная проводимость эмиттера spэ
значительно больше удельной проводимости базы snб. Технология изготовления транзисторов
предусматривает выполнение этого условия и для коллекторного перехода, то есть
spк >> snб
. Ток через базовый контакт Iб является чисто электронным. В стационарном случае он
определяется потоком электронов, которые втягиваются в базу через базовый контакт для
компенсации электронов, уходящих в эмиттер и создающих электронную составляющую тока
эмиттера Inэ , электронов, гибнущих за счет рекомбинации с дырками, инжектируемыми из
эмиттера, за вычетом электронов, поставляемых в базу обратным током коллектора.
Усилительные свойства транзистора обычно характеризуются коэффициентом передачи тока
или коэффициентом усиления, который равен отношению изменения выходного тока к
изменению входного при неизменном чается через a или h31. В соответствии с определением
a = (dIк / dIэ)Vкб=const = g * B * Mк (1)
Параметр g = dIpэ / d(Ipэ + Inэ) называется эффективностью эмиттера, так как он
показывает, какая часть приращения тока эмиттера управляет током коллектора; B = dIpk / dIp
– коэффициент переноса; он показывает, во сколько раз уменьшается приращение дырочного
тока в процессе переноса дырок от эмиттера до коллектора за счет их рекомбинации с
электронами в базе. И наконец, Mк = d(Ipк + Inк) / dIpк называется коэффициентом
умножения коллектора.
10. Энергетическая диаграмма транзистора и распределение концентрации носителей
Энергетическую диаграмму транзистора можно построить на основе энергетической диаграммы p-nструктуры, причём каждый переход имеет свой потенциальный барьер, препятствующий переходу
основных носителей в соседнюю область:
Состояние транзистора, при котором отсутствует напряжение на p-n переходе между эмиттером и базой(Э Б), называют равновесным (рис.а). В равновесном состоянии на обоих переходах устанавливается
динамическое равновесие между потоками дырок и электронов, протекающих в обе стороны.
Каждый p-n переход транзистора можно рассматривать отдельно при условии, что расстояние между
переходами значительно больше диффузионной длины неосновных носителей в средней области. Из-за
наличия потенциальных барьеров в рввновесном сосотоянии на p-n переходах образуется “потенциальная
яма”, из которой могут выйти лишь те электроны, которые обладают достаточной тепловой энергией, и в
равновесном состоянии в обоих переходах устанавливается динамическое равновесие между потоками
электронов.
Анологичное равновесие устанавливается между потоками дырок, которые находятся на “потенциальных
гребнях” и свободно перемещаются в соседнии слои. В равновесном состоянии результирующие токи через
оба терехода равны нулю.
В сплавном транзисторе база однородна, поэтому
механизм перемещения носителей имеет
диффузионный характер и такие транзисторы
называются диффузионными. В рабочем режиме на
переходы транзистора подаются постоянные
напряжения Uэб и Uкб, которые создаются
источниками э.д.c. Еэ и Ек в эмиттерной и
коллекторных цепях:
При подаче на эмиттерный переход прямого напряжения смещения Uэб потенциальный баррьер этого
перехода уменьшается и нарушается равновесное состояние. В результате начнётся взаимная инжекция
носителей в базу и эмиттер(рис.б). При этом в базу инжектируются дырки, которые преодолевают
уменьшившийся потенциальный барьер. Эти дырки проходят через базу и далее через коллекторный
переход в коллектор, образуя коллекторный ток Iк, протекающийчерез нагрузочное сопротивление Rн.
Небольшая часть дырок рекомбинирует в базе, образуя ток базы Iб. Этот ток очень мал, так как база имеет
незначительную длину(меньше длины свободного пробега) и рекомбинация в ней мала.
У транзистора концентрация дырок в р областях много больше концентрации электронов в n области, т.е
Pp>>Nn, поэтому электронной составляющей эмиттерного тока можно пренебречь.
Если в коллекторную цепь включить Rн, то при отсутствии напряжения на коллекторном переходе полезная
мощность на нагрузке не выделяется, т.е усиления не происходит. Чтобы обеспечить усиление, на
коллекторный переход необходимо подать запирающее отрицательное напряжение Uкб, что приведёт к
возрастанию потенциального барьера коллекторного перехода.
Принцип действия транзистора состоит в управлении током одного из переходов с помощью тока другого
перехода. При снижении потенциального барьера Uбэ на эмиттерном переходе возрастает поток дырок,
уходящих в базу и диффундируующих далее к коллекторнуму переходу. Попадая в коллектор эти дырки
создают коллекторный ток Iк, протекающий через нагрузку. Следует поподробнее остановится на эффекте
усиления мощности. Нагрузочное сопротивление Rн подключается последовательно с коллекторным
переходом. На этом переходе имеется значительная разность потенциалов, которую приходится
преодолевать току, обусловленному диффузией из эмиттера.
Токи в транзисторе
В результате снижения потенциального барьера на эмиттерном переходе из эмиттера в базу
начинается диффузионное движение основных носителей.Так как дырок(электронов) в
эмиттере(базе) много больше,чем в базе(эмиттере), то коэффициент инжекции весьма
высок.Концетрация дырок в базе увеличивается.Появившийся вблизи эмиттерного перехода
объемный положительный заряд почти мнгновенно компенсируется зарядом электронов
входящих в базу от источника Uэб.Цепь тока Эмиттер-База замкнута. Электроны
устремившиеся в базу создают вблизи эмиттерного перехода объемный отрицательный
заряд.Около перехода образуется область повышенной концетрации дырок и
электронов.Они начинают диффундировать в сторону коллектора.Так как база узкая, то
дырки (неосновные носители) не успевают прорекомбинировать и ,попадая в ускоряющее
поле коллекторного перехода , втягиваются в коллектор.Этот процесс называется
экстракция. Электроны же, число которых равно числу ушедших в коллектор дырок,
устремляются в базовый вывод. Цепь коллектор-база замкнута.
Iэ = Iк + Iб
Iэ – ток в цепи эмиттера,
Iк – ток в цепи коллектора,
Iб – ток на базовом выводе.
В активном режиме к эмиттеру приложено прямое напряжение и через переход течет ток
Iэ = Iэр + Iэn + Iэr,
где Iэр – ток инжекции дырок из эмиттера в базу,Iэn – ток инжекции электронов из базы в
эмиттер, Iэr – ток рекомбинации в эмиттерном переходе.
Iобр = Io + Ig + Iу,
где Io -т епловой ток,Ig – ток генерации,Iу – ток утечки.
Iкр = Iэр – Iбr.
Статические характеристики и
коэффициент передачи тока в различных
схемах включения.
Схема с общей базой
При включении транзистора по схеме с общей базой (рис.1) входным является ток эмиттера, а
выходным – коллектора. Коэффициент передачи тока в этом случае определяется формулой (1) :
a = (dIк / dIэ)Vкб=const =g * b * Mк (1)
Семейство входных статических характеристик, то есть зависимость Iэ от Vэб при фиксированных
значениях Vкб, описывается выражением (2):
jэ = jps / sh(W/Lp) * { [ exp(q * Vэб / k * T) – 1] * ch(W/Lp) – – [ exp(q * Vкб / k * T) – 1 ] } + jns * [
exp(qVэб / k * T) – 1 ]. (2)
Если Vкб=0, то Iэ ~ [ exp( q * Vэб / k * T ) – 1 ] (рис.2, кривая 1). При Vкб
эмиттерный ток, как следует из (2) отличается от нуля. Обычно при работе транзистора в
режиме усиления | Vкб | > 2,3k * T / q, но тогда p(W) = -pn, а p = pn. Таким образом, в
рассматриваемой ситуации в базе транзистора существует градиент концетрации дырок и
Iэ не равно 0. Для компенсации этого тока на эмиттерный переход необходимо подать
смещение в запорном направлении ( рис. 2, кривая 2). Семейство выходных
характеристик ( зависимость Iк от Vкб при фиксированных значениях Iэ ) описывается
формулой (3) :
jк = jps / sh(W/Lp) * { [ exp(q * Vэб / k * T) – 1 ] – – [ exp (q * Vкб / k * T) – 1 ] * ch(W/Lp) } jns * [ exp(q * Vкб / k * T) – 1 ] (3)
В том случае, когда Iэ = 0 и Vэб = 0, а Vкб
Iк0 = – [ Ipsк * cth(W / Lp) + Insк][ exp( – q * |Vкб| / k * T) – 1 ], (4)
где Ipsк = jps * Sк, Insк = jns * Sк, а Sк – площадь коллекторного перехода. На рис. 3 этому
выражению соответствует кривая 1. Поскольку spэ >> snб, то jps >> jns и последним членом в (2)
можно пренебречь. Кроме того, обычно exp(q * Vэб / k * * T) – 1 >> exp( – q * |Vкб | / k * T) – 1. С
учетом этих обстоятельств из (2) следует, что Iэ Ipsэ * cth(W / Lp) * [ exp(q * |Vэб| / k * T) – 1 ], где
Ipsэ = jps * Sэ, а Sэ – площадь эмиттерного перехода. Тогда, пологая, что Sк = Sэ, можно (3)
переписать в виде:
Iк ~ a0 * Iэ + Iк0. (5)
Здесь предполагается, что g0 = 1 и a0 = sch ( W / Lp ).
Полученное соотношение устанавливает связь выходного тока с
током эмиттера, который выступает здесь в качестве параметра. Из
(4) и (5) следует, что при Vкб = 0 Iк0 = 0, а Iк ~ a0 * Iэ. Для
компенсации потока дырок из эмиттерного в коллекторный переход
на последний необходимо подать напряжение смещения в
пропускном направлении. В связи с этим все выходные
характеристики при Iэ не равному 0 начинаются в области
положительных значений Vкб ( рис. 3, кривые 2 и 3 ).Поскольку a0 ~
1, Iк0, то из (5) видно, что Iк Iэ и фактически не зависит
от Vкб в области его отрицательных значений. При достаточно
больших обратных смещениях на коллекторном переходе в нем
развивается обычно лавинный пробой и на выходной
характеристике появляется участок резкой зависимости Iк от
Vкб (рис. 3). Большой ток может протекать через транзистор и в
случае прокола базы, когда эмиттерный и коллекторный переходы
сомкнутся за счет расширения ООЗ последнего при увеличении
Vкб.
Схема с общим эмиттером
На практике довольно часто используются транзисторы, включенные по схеме с общим эмиттером
(рис. 4).
В этой схеме входным является ток базы, а выходным, как и в предыдущем
случае, ток коллектора. В соответствии с определением коэффициента
передачи тока для схемы с общим эмиттером будем иметь h31э * B0=dIк /
dIб, но Iб=Iэ * Iк, и, следовательно,
B0 = dIк / (dIэ – dIк) = a0 / (1 – a0) . (6)
Отсюда видно, что В0 должен быть значительно больше a0. Действительно, при a0=0,95 B0=19.
Поскольку рассматриваемая схема включения транзистора отличается от схемы с общей базой
только тем, что вместо базы заземляется эмиттер, то для описания входных и выходных
характеристик можно воспользоваться соотношениями, полученными в предыдущем разделе.
Исходя из этого, для тока базы с учетом (5) можно записать
Iб=Iэ -Iк = (1 – a0) * Iэ – Iк0. (7)
Поскольку при выводе (5) мы полагали, что a0 = b0 = dIpк / dIpэ, тo первая составляющая тока в
(7) обусловлена электронами, входящими в базу транзистора для компенсации их потерь на
рекомбинацию с инжектированными из эмиттера дырками. Вторая составляющая тока связана
с электронами, которые выбрасываются в базу обратносмещенным коллектором, частично
компенсируя потери на рекомбинацию. Электронный ток через эмиттер при записи выражений
(5) и (7) не учитывался. Анализ общего вида входных характеристик, представляющих собой
зависимость Iб от Vбэ при фиксированных значениях Vкэ, проведем на основе выражения (7),
учитывая, что Vкэ Vкб – Vбэ.
Если Vкэ=0, то входная характеристика должна изображаться кривой, выходящей из начала
.координат (рис. 5, кривая 1), так как при Vбэ = 0 Vбк и Iк0 также равны нулю. При Vкэ
коллектор должен быть смещен в запорном направлении. Тогда при Vбэ = 0 Iб = – Iк0, то есть начало
входной характеристики располагается в области отрицательных значений тока (рис. 5, кри-вая 2). В
целом ход зависимости Iб от Vбэ определяется эмиттерным током ( Iэ exp(q * Vбэ / k * T) – 1 ), и по
своей форме входные характеристики подобны вольтамперной характеристике р-n-перехода,
смещенного в пропускном направлении. Подставляя в (5) вместо Iэ сумму Iк + Iб, после несложных
преобразований получим
Iк = B0 + I*к0, (8)
где Iк0 =Iк0 / (1 – a0). На основе этого выражения можно провести качественный анализ выходных
характеристик транзистора, включенного по схеме с общим эмиттером (рис. 6).
Прежде всего из (8) следует, что при разомкнута входе (Iб= 0) ток через
коллекторнный переход значительно больше, чем в схеме с общей базой, то есть
Iк0 >> Iк0. Для поддержания базового тока постоянным при любом Vкэ необходимо
зафиксировать значение Vбэ. Но тогда Vкэ ~ Vкб – Vбэ может обратиться в нуль
только в том случае, если коллекторный переход сместится в пропускном
направлении. В этой ситуации и эмиттерный, и коллекторный переходы
инжектируют дырки а базу транзистора навстречу друг другу и при Vкэ = 0 ток
коллектора при любом фиксированном значении Iб принимает нулевое значение
(рис. 6). При перемещении вдоль выходной характеристики в сторону увеличения
тока падение напряжения на кол-лекторном переходе Vkб в области малых
значений Vкэ положительно, затем переходит через нуль, меняет знак на
противоположный и непрерывно увеличивается. По мере увеличения Vкб, за счет
расширения ООЗ коллек-торного перехода уменьшается ширина базы транзистора и, следовательно, увеличивается a0 . Это приводит к существенному росту Во
[см. (6)] и Iк [см. (8)] при увеличении Vкэ (рис. 6).
Схема с общим коллектором
В этой схеме включения так же, как и в предыдущем случае, управляющим (или входным)
является ток базы, но роль выходного играет ток эмиттера (рис. 7). Коэффициент передачи тока
B0* = dIэ / dIб = 1 / (1 – a0). (9)
Поскольку a0 ~ 1, то B0*>>1. Входной ток в данном случае практически не
зависит от входного напряжения. Выходной ток Iэ = Iб + Iк или с учетом (8)
Iэ = B0*Iб + Iк0* (10)
то есть выходные характеристики подобны характеристикам транзистора,
включенного по схеме с общим эмиттером. Из (10) видно, что выходной ток (Iэ)
значительно больше входного (Iб), а падения напряжения на входе и выходе
примерно одинаковы ( Vбк Vэк ). Отсюда следует, что транзистор, включенный
по схеме с общим коллектором, обладает высоким сопротивлением на входе и
малым на выходе. Это свойство транзистора используется для согласования
схем с различными сопротивлениями.
Влияние температуры на
характеристики транзисторов
Существенным недостатком транзисторов является зависимость их характеристик от изменения
температуры, или температурная нестабильность.
При повышении температуры увеличивается электропроводность полупроводников и токи в них
возрастают. В наибольшей степени возрастает обратный ток p-n перехода(начальный ток
коллектора). Это приводит к изменению характеристик p-n перехода.
Схемы с общей базой и общим эмиттером имеют различные значения обратного тока Iкбо. С
увеличениием температуры T обратные токи возрастают, но соотношение между ними остается
постоянным (рис.1 а).
Одновременно температурные изменения оказывают влияние на величину коэффициентов
передачи тока а и B (рис.1 б). С физической точки зрения изменения этих параметров
определяется комплексом факторов, среди которых в первую очередь необходимо отметить
изменение концентрации носителей и диффузионной длины, влияние центров захвата.
Изменение обратных токов и коэффициентов усиления приводит к смещению входных и
выходных характеристик транзисторов, что может привести к нарушению его нормальной работы
или схемы на его основе.
Сравним влияние изменения температуры на выходные и входные характеристики для схем с
общей базой и общим эмиттером. Используем выражение:
Iк = аIэ+Iкбо (1)
Относительное изменение Iк можно найти, продифференцировав (1):
dIк/Iк = (Iэ/Iк)da + dIкбо/Iк = da/a + (Iкбо/Iк)*(dIкбо/Iк)
Соотношение между относительными изменениями тока Iк в схеме с общим эмиттером и общей
базой следующее:
(dIк/Iк)оэ = (1 + B)*(dIк/Iк)об
Это означает, что характеристики в схеме с общей базой более стабильны к изменению
температуры, чем в схеме с общим эмиттером.
На (рис.2) приведена выходная и входная характеристики биполярного транзистора, включенного по
схеме с общим эмиттером при различных температурах:
При работе транзисторов необходимо знать допустимые пределы или диапазоны изменения
температуры окружающей среды и самих приборов, при которых гарантируется их надёжная
работа.Для характеристики этих режимов вводятся тепловые параметры транзисторов,
которые указываются в их паспортных данных.
При увеличении температуры транзистора возрастает максимальная мощность,
рассеиваемая на коллекторном переходе. Для определения засимостей между рассеиваемой
мощностью и температурой кристалла используют зависимость:
Tп = Tкорп + P * Rt,
где Tп, Tкорп – температуры p-n перехода и корпуса; P – мощность, рассеиваемая на
переходе; Rt – тепловое сопротивление переход – окружающая среда, которое показывает на
сколько градусов повысится температура перехода относительно окружающей среды при
рассеивании на переходе заданой мощности; его величина приводится в справочниках по
транзисторам.
Для транзисторов большой мощности, в которых применяются теплоотводы, вместо
величины Rt используется тепловое сопротивление переход – корпус. Эти формулы
применимы для определения средней температуры транзисторов. При работе в импульсных
режимах могут возникать мгновенные значения температуры, значительно превышающие
средние значения, поэтому для транзисторов устанавливается величина допустимого
мгновенного значения температуры.
Емкости транзистора
При рассмотрении схемы замещения транзистора было установлено, что его p-n переходы
имеют емкости, которые в схеме замещения учтены конденсаторами Сэ (емкость
эмиттерного перехода) и Ск (емкость коллекторного перехода), причем эти емкости
шунтируют сопротивление эмиттера Rэ и коллектора Rк. С увеличением рабочей частоты
емкостные сопротивления эмиттера и коллектора уменьшаются и их шунтирующее
действие возрастает.
Исследование этих емкостей необходимо для изучения свойств транзисторов,
работающих на высоких и сверхвысоких частотах.При рассмотрении емкости p-n перехода
было установлено,что она складывается из барьерной емкости Сб, зависящей от
объемного заряда в области p-n перехода, и из диффузионной Сд ,зависящей от тока
диффузии и времени жизни носителей.Выражения,выведенные для расчета емкости p-n
перехода диодов,могут быть использованы при рассмотрении транзисторов.
Для суммарных емкостей Ск и Сэ имеем
Ск = Скб + Скд, Сэ = Сэб + Сэд,
где Скб,Сэб – барьерные емкости коллекторного и эмиттерного переходов; Скд,Сэд диффузионные емкости коллекторного и эмиттерного переходов.
Диффузионная емкость коллектоного перехода обусловлена приращением заряда
неравновесных носителей в базе,вызываемым модуляцией толщины базы.Для большинства
транзисторов выполняется соотношение Скб >> Скд,поэтому емкость коллектора
принимаем равной барьерной Ск =С кб. Для ее определения имеем формулу
Аналогично для эмиттерного перехода получаем значение
Наряду с барьерной емкостью в транзисторе имеет место диффузионная емкость, обусловленная
изменением заряда неравновесных носителей при приращении напряжения на эмиттерном
переходе(при постоянном коллекторном напряжении):
Величина заряда Q определяется соотношением
Тогда
где tд – среднее время диффузии.
Емкость Сэд значительно превышает Скд , так как приращение Uэб
влияет непосредственно на величину заряда , а приращение Uкб
влияет на заряд косвенно благодаря модуляции толщины базы.
Работа транзистора на высокой частоте.
Свойства транзистора на высоких частотах удобно анализировать по расмотренной схеме
замещения. На работу Б.Т. вредное влияние оказывает емкостное сопротивление коллекторного
перехода Cк. На низких частотах емкостное сопротивление этого перехода (1 / WCk) велико.
Велико и сопративление rk; поэтому весь ток эквивалентного генератора Iг = aIэ идет через
нагрузку, роль которой выполняет резистор Rн.
С повышением частоты сопротивление 1 / WCк начинает уменьшатся и при некоторой частоте
часть тока, создавемого генератором, начинает отделяться в емкость Ск и ток через rн начинает
падать. Это явление равносильно уменьшению коэффициента усиления транзистора, т.к.
полезная выходная мощность уменьшается с уменьшением тока нагрузки. Следовательно с
увеличением частоты уменьшается коэффиценты усиления a и B.
С увеличением частоты сопротивление 1 / WCэ также уменьшается, но влияние Cэ не
проявляется так сильно, как влияние Cк. Это объясняется тем, что емкость Cэ зашунтирована rэ
(сопротивление эммиторного перехода), имеющим очень малую величину. Сопротивление 1 /
WCэ начинает оказывать влияние на очень высоких частотах, где оно становится соизмеримым с
rэ. На этих частотах транзистор обычно не работает, т.к. емкость Cк почти полностью шунтирует
генератор тока Iг. Следовательно влиянием Cэ можно пренебречь.
Вторая причина, вызывающая уменьшение коэффициента усиления, является инерционность
процесса перемещения носителей через базу от эмиттерного перехода к колекторному в
результате чего появляется запаздывание по фазе между изменением величин Iэ и Iк. Это
запаздывание определяется временем переноса неосновных носителей через базу и зависит
от её толщины.
Частота на которой модуль коэффициента передачи, a уменьшается в корень из двух раз по
сравнению с его значением на низкой частоте, называется граничной частотой fгр.Величина
fгр для схемы с О.Б. определяется из соотношения fгр = п / tD, где tд = W * W / 2Dр – среднее
время диффузии носителей.
Коффицент передачи тока эмитера a зависит от частоты следующим образом
a(iW) = a0 / (1+ iW / Wa),
где Wa = 2п * fгр – угловая граничная частота, i- мнимая еденица.
Комплексное число, стояшее в знаменатели указывает, что изменение коэффициэнта
передачи определяется физическими процесами, эквивалентными изменению комплексного
(емкостного) сопротивления.
Модуль коэффициента передачи зависит от угловой частоты W = 2пt следующим образом:
Угол запаздывания по фазе между эмиттерным и коллекторным токами можно определить как
Y(a)= – W / Wa
Чтобы охарактеризовать частотные свойства транзистора широко используются частотные
характеристики; представляющие собой зависимость модуля коэффициэнта передачи a от частоты
(АЧХ) и фазы Y(a) (ФЧХ)(рис.1). С увеличением частоты W увеличивается сдвиг по фазе Y,
обусловленный влиянием инерционных процессов при прохождении неоснавных носителей через
базу; и вконечном счете уменьшается коэффициэнт a. В схеме с общим эмитором величига
коэффициэнта передачи тока базы в более сильной степени звисит частотаы, что приводит к
уменьшению граничной частоты в схеме с ОЭ.
Уменьшение коэффициента a происходит в результате того, что с повышением частоты ток
коллектора отстает от тока эмиттера. Граничные частоты для схемы с ОБ и ОЭ связаны
формулой:
Wб = W * (1 – a0) = Wa /(1 + B0),
где B – модуль коэффициэнта передачи тока базы при W = 0. Граничная частота в схеме с ОЭ
в 1 + B0 раз меньше чем в схеме с ОБ.
Динамический режим работы транзистора
При работе транзистора с нагрузкой имеет место взаимное влияние друг на друга токов Iэ, Iк, Iб.
Этот режим носит название динамического, а его характеристики – динамических.
Рассмотрим динамический режим транзистора, работающего по схеме с ОЭ (рис.1). При работе
транзистора совместно с нагрузкой Rн, включенной в цепь коллектора, напряжение источника
питания Ек распределяется между нагрузкой и переходом коллектор – эмиттер (Uкэ): Ек = Uкэ +
Iк * Rн, поэтому ток коллектора изменяется по линейному закону в соответствии с выражением Iк
= (Ек – Uкэ) / Rн. Графическая зависимость Iк = f(Uкэ) представляет собой прямую линию,
которая называется нагрузочной прямой. Для ииследования свойств транзистора нагрузочную
кривую наносят на семейство вяходных характеристик (рис.1б). Точка пересечения нагрузочной
прямой с осью токов сопадает с точкой, для которой удовлетворяется условие Iк * Rн = Ек.
Входная динамическая характеристика представляет собой зависимость входного тока от
входного напряжения в динамическом режиме (рис.1в). На этой характеристике штриховой
линией нанесена входная динамическая линия нагрузки, которая строится по точкам
пересечения выходных динамических характеристик с нагрузочной прямой.
Работа транзистора в импульсном режиме
Работа транзистора в качестве усилителя малых импульсных сигналов в принципе ничем не
отличается от от работы транзистора как усилителя малых синусоидальных сигналов. Импульс
можно в виде суммы ряда гармонических составляющих и, зная частотые свойства
транзистора, определить искажения формы импульса, которые могут происходить при
усилении. Особый режим работы имеет место в том случае, когда рабочая точка
перемещается в значительной области в значительной области выходных характеристик от
одного края области к другому. Транзистор может при этом работать в трёх основных режимах
(рис.1б):
1.Режим насыщения (точка А). В этом режиме транзистор полностью открыт и протекающий
ток равен максимальному значению: Iк = Ек / Rн.
2.Режим отсечки (точка В). В этом режиме транзистор заперт и ток его близок к нулю.
3.Активный режим – режим работы транзистора, при котором транзистор обладает
активными свойствами, т.е способен обеспечивать усиление по мощности. В этом режиме
рабочая точка лежит между точками А и В.
Скорость перехода транзистора из открытого состояния в закрытое и обратно главным
образом зависит от переходных процессов в базе, связанных с накоплением и рассасыванием
неравновесных носителей зарядов. На вход транзистора подаётся управляющий сигнал в
виде скачков напряжения, замыкяющих и размыкающих транзисторный ключ.
Рассмотрим процессы, происходящие в транзисторе, включённом по схеме с ОБ при подаче
через эмиттер импульса длительностью tимп, в прямом направлении с последуюшим
изменением полярности (рис.2а). В исходном состоянии транзисторный ключ заперт, т.е
эмиттерный и коллекторный переходы заперты, и транзистор работает в режиме отсечки.
После подачи через эмиттер импульса в прямом направлении ток коллектора появляется не
сразу из-за конечного времени пролета инжектированных носителей до коллекторного
перехода и наличия барьерных емкостей (рис.1а). Время, на которое появление
коллекторного тока отстает от змиттерного, называют временем за держки tзд. Процесс
установления тока коллектора характеризуется временем нарастания tнр. Это время
затрачивается на диффузионное перемещение через базу инжектированных в неё носителей.
Следует заметить, что tзд относительно мало и во многих случаях при приближенных
расчетах им пренебрегают.
При Iэ > 0 с увеличением эмиттерного тока быстро возрастает и коллекторный ток Iк – это активный
режим работы транзистора. Наконец, когда рабочая точка на нагрузочной характеристике достигает
точки перегиба статических выходных характеристик, дальнейшее увеличение тока Iэ нe вызывает
роста коллекторного тока Iк, транзисторный ключ полностью открылся и транзистор работает в
режиме насыщения.
Через интервал времени, равный tимп меняется полярность напряжения, подаваемого на эмиттер.
При этом транзистор в течение некоторого времени tрас (время рассасывания) продолжает
находиться в режиме насыщения.
Рассасывание заряда происходит вследствие ухода дырок из базы через коллекторный и
эмиттерный переходы. До тех пор пока в процессе рассасывания концентрации неосновных
носителей около р-n переходов не достигнут нуля, обратные токи через соответствующие р-n
переходы будут оставаться постоянными, т.е токи эмиттера и коллектора будут неизменными,пока
транзистор нахoдится в режиме насыщения. В момент времени tрас избыточная концентрация
неосновных носителей в базе около коллекторного р-n перехода достигает нуля. С этого момента
ток коллектора и ток эмиттера будут уменьшаться. Время рассасывания tрас определяется как
интервал времени с момента выключения входного импульса и связанного с этим изменением
направления тока базы до момента, когда концентрация дырок у коллекторного перехода
уменьшится до нуля. Величина его зависит от конструкции эмиттера, величины его тока и
длительности импульса tимп. Для уменьшения tрас на входе цепи в момент окончания действия
импульса создают ток обратного направления Iэ2, что ускоряет рассасывание дырок в базе. По
истечении времени tрас, рабочая точка транзистора переходит на границу активной области и
начинается спад выходного тока. Длительность спада tсп определяется как время, в течение
которого ток уменьшается от 0,9 до 0,1 тока насыщения.
За время tнр в базе транзистора накапливаются неосновные носители, а в процессе
рассасывания за время tрас происходит уменьшение неосновных носителей по ширине базы W в
соответствии с диаграммами, представленными на (рис.2б).
Физические процессы, протекающие в транзисторе при нарастании и спаде напряжения,
иллюстрируются диаграммами распределения неосновных носителей Pn, построенными для
различных моментов времени 1…9, соответствующих характерным точкам переходного процесса,
изображённого на (рис.2б).
Параметры транзистора как элемента цепи
Транзистор является управляемым элементом цепи. Если на входе транзистора нет
управляющего сигнала , то является пассивным элементом. Если к входу транзистора
приложено переменное напряжение ,то транзистор приобретает свойства активного элемента
и отдаёт мощность нагрузке. В усилительном режиме на входе транзистора действует
переменное напряжение, поэтому он является активным четырёхполюсником.
Если переменные напряжения на переходах транзистора достаточно малы, токи в нём
оказываются линейными функциями этих напряжений. Транзистор можно рассматривать как
линейный четырёхполюсник.
Переменные величины i1, u1, i2, u2, характеризующие электрические свойства транзистора,
взаимно связаны. Если любые две из них заданы, то оставшиеся определяются однозначно
по параметрам транзистора. За независимые переменные можно принять две любые из
этих величин, а две другие – представить в виде функции независимых переменных.
Параметры холостого хода (z-параметры)
Вводя новые обозначения для частных производных, имеющих размерность сопротивлений, и
заменяя дифференциалы токов и напряжений комплексными амплитудами малых переменных
сигналов( U и I ), получаем:
U1 = Z11 I1 + Z12 I2; (1)
U2 = Z21 I1 + Z22 I2, (2)
где Z11, Z12, Z21, Z22 – характеристические сопротивления транзистора.
Характеристические сопротивления называют параметрами холостого хода, так как они
определяются при условии холостого хода входа или выхода по переменному току т.е при
равенстве нулю однго из токов в уравнениях (1) и (2).
Входное сопротивление транзистора при холостом ходе на выходе:
Z11 = U1/I1, при I2 = 0
Сопротивление обратной связи (обратной передачи) при холостом ходе на выходе:
Z12 = U1/I2, при I1 = 0
Сопротивление прямой передачи (сопротивление усиления) при холостом ходе на выходе:
Z21 = U2/I1, при I2 = 0
Выходное сопротивление транзистора при холостом ходе на входе:
Z22 = U2/I2, при I1 = 0
Зависимость z-параметров от режима работы легко выражается аналитически. Недостатком
является трудность измерения параметра Z11, т.е осуществления режима холостого хода по
переменному току на выходе, вследствие большого выходного сопротивления
Параметры короткого замыкания (y-параметры)
Зависимость токов от напряжения можно записать так (I1, U1, I2, U2-комплексные амплитуды
малых переменных сигналов):
I1 = Y11 U1 + Y12 U2;
I2 = Y21 U1 + Y22 U2,
где Y11, Y12, Y21, Y22 – характеристические проводимости четырёхполюсника, которые
определяются при условии короткого замыкания входа или выхода транзистора по
переменному току.
Входная проводимость при коротком замыкании выхода:
Y11 = I1/U1, при U2 = 0
Проводимость обратной связи (обратной передачи) при коротком замыкании входа:
Y12 = I1/U2, при U1 = 0
Проводимость прямой передачи (усиления) при коротком замыкании выхода:
Y21 = I2/U1, при U2 = 0
Выходная проводимость при коротком замыкании входа:
Y22 = I2/U2, при U1 = 0
Смешанная система параметров (h-параметры)
Выражения для токов и напряжений можно записать так (I1, U1, I2, U2-комплексные амплитуды
малых переменных сигналов):
U1 = h21 I1 + h22 U2;
I2 = h31 I1 + h32 U2,
где h21, h22, h31, h32 – гибридные (смешанные) параметры четырёхполюсника.
В отличие от y- и z-параметров h-параметры имеют различную размерность. Это
объясняется тем, что в качестве независимых параметров взяты различные по
размерностям величины – входной ток I1 и выходное напряжение U2.
Входное сопротивление:
h21 = U1/I1, при U2 = 0
Коэффициент обратной связи по напряжению:
h22 = U1/U2, при I1 = 0
Коэффициент передачи по току (коэффициент усиления):
h31 = I2/I1, при U2 = 0
Выходная проводимость:
h32 = I2/U2, при I1 = 0
Достоинством системы h-параметров является лёгкость измерения её параметров.
Технологические разновидности биполярных
транзисторов
Среди многочисленных разновидностей транзисторов наибольшее распространение получили сплавные, сплавнодиффузионные, диффузионно-планарные, мезапланарные и эпитаксиально-планарные транзисторы (рис. 1).
Сплавные транзисторы (преимущественно германиевые) изготовляют по сплавной технологии получения p-nпереходов. Транзисторная структура с двумя близко расположенными p-n-переходами показана на рис. 2, а одна из
наиболее распространенных конструкций сплавного транзистора – на рис. 3 (где 1 – кристалл Ge; 2 кристаллодержатель; 3 – электрод эмиттера; 4 – электрод коллектора; 5 – базовое кольцо; 6 – корпус; 7 основание; 8 – выводы). В сплавных транзисторах трудно сделать очень тонкую базу, поэтому они предназначены
только для низких и средних частот, их могут выпускать на большие мощности, до десятков ватт. В мощных
транзисторах электронно-дырочные переходы выполняют большой площади, вывод коллектора соединяется с
корпусом. Основание корпуса для лучшего охлаждения изготавливают в виде массивной медной пластины, которую
монтируют на теплоотводе или на шасси электронной схемы. Недостатки сплавных транзисторов – сравнительно
невысокая предельная частота fa 20 МГц, значительный разброс параметров и некоторая нестабильность свойств
транзистора во времени. Сплавно-диффуэионные транзисторы изготавливают сочетанием сплавной технологии с
диффузионной. В этом случае наплавляемая навеска содержит как донорные (сурьма), так и акцепторные (индий)
примеси. Навески размещают на исходной полупроводниковой пластине и прогревают. При сплавлении образуется
эмиттерный переход. Однако при высокой температуре одновременно с процессом плавления происходит диффузия
примесей из расплава в глубь кристалла. Примеси доноров и акцепторов распределяются по толщине кристалла при
этом неравномерно, так как разные примеси диффундируют на разную глубину (например, диффузия сурьмы идет
скорее, чем индия). В кристаллов результате образуется диффузионный базовый слой n-типа с неравномерным
распределением примесей (получается «встроенное» в базу электрическое поле). Коллектором служит исходная
пластинка герма-ния p-типа. Перенос неосновных носителей через базовую область осуществляется в основном
дрейфом во «встроенном» электрическом полем транзисторы поэтому называют дрейфовыми. Толщина базы
транзисторов .может быть уменьшена до 0,5-1 мкм. Рабочие частоты достигают 500-1000 МГц. Широкий диапазон
частот является основным достоинством этой разновидности транзисторов. К недостаткам относятся низкие
обратные напряжения на эмиттере из-за сильного легирования эмиттерной области, а также трудности в разработке
транзисторов на высокие напряжения и большие мощности. В последние годы при изготовлении дрейфовых
транзисторов широко используется метод двойной диффузии. В этом случае базовая и эмиттерная области
получаются при диффузии примесей п- и p-типа в исходную пластинку полупроводника. Такие транзисторы
изготавливают в виде планарных структур и меза-структур.
Классификация транзисторов
Транзисторы классифицируются по допустимой мощности рассеивания и по частоте. В соответствии с принятой
классификацией транзисторы по величине мощности, рассеиваемой коллектором, делятся на транзисторы малой
(Рк ЗООО мВт), средней (Рк 1,5 Вт) и большой (Рк 1,5 Вт) мощности. По значению предельной частоты, на
которой могут работать транзисторы, их делят на низкочастотные (З МГц), среднечастотные ( ЗО МГц),
высокочастотные ( 300 МГц) и сверхвысокочастотные ( > ЗООМГц). Низкочастотные маломощные
транзисторы обычно изготавливают методом сплавления, поэтому их называют сплавными. Так как при
изготовлении низкочастотных сплавных транзисторово бычно используют равномерно легированный исходный
материал, то при малых токах электрическое поле в области базы таких транзисторов отсутствует и по механизму
движения носителей они относятся к бездрейфовым. К высокочастотным относят транзисторы с рабочими
частотами свыше 30 МГц. Для обеспечения работы транзистора на таких частотах требуется уменьшить время
пролета носителей через базу и область объемного заряда коллектора, уменьшить барьерные емкости и
объемные сопротивления базы и коллектора. Выполнить все это на основе сплавной технологии невозможно.
Основным методом изготовления высокочастотных транзисторов является диффузия примесей, такие
транзисторы поэтому часто называют диффузионными. При диффузии примеси в базе распределяются
неравномерно, там создается электрическое поле. Следовательно, по механизму движения носителей
диффузионные транзисторы могут относиться к дрейфовым.
Классификация транзисторов отражена в их обозначениях.
В соответствии с ГОСТ 10862-72 транзисторам присваиваются обозначения, состоящие из четырех элементов:
Первый элемент – буква или цифра, обозначающая исходный материал: R или 1 – германий; К, или 2 – кремний;
А или 3- арсенид галлия.
Второй элемент – буква Т для биполярных транзисторов, бук-ва П-для униполярных (полевых) транзисторов.
Третий элемент обозначения транзисторов определяет их классификацию подгруппам рассеиваемых
мощностей (малая, средняя, большая) и граничной частоте fгр коэффициента передачи тока.
Четвертый и пятый элементы определяют порядковый номер разработки технологического типа прибора и
обозначаются от 01 до 99.
Примеры обозначений:
2Т144А – транзистор кремниевый, малой мощности, fгр не более 3МГц, номер разработки 44, группа А.
ГТ605А – транзистор германиевый, средней мощности, fгр не более 30 МГц, номер разработки 05, группа А.
Как устроен транзистор. Как работает биполярный транзистор. Как работает транзистор
Первоначальное название радиодетали – триод, по числу контактов. Этот радиоэлемент способен управлять током в электрической цепи, под воздействием внешнего сигнала. Уникальные свойства применяются в усилителях, генераторах и других аналогичных схемных решениях.
Обозначение транзисторов на схеме
Долгое время в радиоэлектронике царствовали ламповые триоды. Внутри герметичной колбы, в специальной газовой или вакуумной среде размещались три основных компонента триода:
Когда на сетку подавался управляющий сигнал небольшой мощности, между катодом и анодом можно было пропускать несравнимо большие значения. Величина рабочего тока триода многократно выше, чем управляющего. Именно это свойство позволяет радиоэлементу выполнять роль усилителя.
Триоды на основе радиоламп работаю достаточно эффективно, особенно при высокой мощности. Однако габариты не позволяют применять их в современных компактных устройствах.
Представьте себе мобильный телефон или карманный плейер, выполненный на таких элементах.
Вторая проблема заключается в организации питания. Для нормального функционирования, катод должен быть сильно разогрет, чтобы началась эмиссия электронов. Нагрев спирали требует много электроэнергии. Поэтому ученые всего мира всегда стремились создать более компактный прибор с такими же свойствами.
Первые образцы появились в 1928 году, а в середине прошлого столетия был представлен работающий полупроводниковый триод, выполненный по биполярной технологии. За ним закрепилось название «транзистор».
Что такое транзистор?
Транзистор – полупроводниковый электроприбор в корпусе или без него, имеющий три контакта для работы и управления. Главное свойство такое же, как у триода – изменение параметров тока между рабочими электродами при помощи управляющего сигнала.
Благодаря отсутствию необходимости разогрева, транзисторы затрачивают мизерное количество энергии на обеспечение собственной работоспособности. А компактные размеры рабочего полупроводникового кристалла, позволяют использовать радиодеталь в малогабаритных конструкциях.
Благодаря независимости от рабочей среды, кристаллы полупроводника можно использовать как в отдельном корпусе, так и в микросхемах. В комплекте с остальными радиоэлементами, транзисторы выращивают прямо на монокристалле.
Выдающиеся механические свойства полупроводника нашли применение в подвижных и переносных устройствах. Транзисторы нечувствительны к вибрации, резким ударам. Обладают неплохой температурной стойкостью (при сильной нагрузке применяют радиаторы охлаждения).
Если рассматривать механические аналоги, то работа транзисторов напоминает принцип действия гидравлического усилителя руля в автомобиле. Но, сходство справедливо только при первом приближении, поскольку в транзисторах нет клапанов. В этой статье мы отдельно рассмотрим работу биполярного транзистора.
Устройство биполярного транзистора
Основой устройства биполярного транзистора является полупроводниковый материал. Первые полупроводниковые кристаллы для транзисторов изготавливали из германия, сегодня чаще используется кремний и арсенид галлия. Сначала производят чистый полупроводниковый материал с хорошо упорядоченной кристаллической решеткой. Затем придают необходимую форму кристаллу и вводят в его состав специальную примесь (легируют материал), которая придаёт ему определённые свойства электрической проводимости. Если проводимость обуславливается движением избыточных электронов, она определяется как донорная (электронная) n-типа. Если проводимость полупроводника обусловлена последовательным замещением электронами вакантных мест, так называемых дырок, то такая проводимость называется акцепторной (дырочной) и обозначается проводимостью p-типа.
Рисунок 1.
Кристалл транзистора состоит из трёх частей (слоёв) с последовательным чередованием типа проводимости (n-p-n или p-n-p). Переходы одного слоя в другой образуют потенциальные барьеры. Переход от базы к эмиттеру называется эмиттерным (ЭП), к коллектору – коллекторным (КП). На рисунке 1 структура транзистора показана симметричной, идеализированной. На практике при производстве размеры областей значительно ассиметричны, примерно как показано на рисунке 2. Площадь коллекторного перехода значительно превышает эмиттерный. Слой базы очень тонкий, порядка нескольких микрон.
Рисунок 2.
Принцип действия биполярного транзистора
Любой p-n переход транзистора работает аналогично . При приложении к его полюсам разности потенциалов происходит его “смещение”. Если приложенная разность потенциалов условно положительна, при этом p-n переход открывается, говорят, что переход смещён в прямом направлении. При приложении условно отрицательной разности потенциалов происходит обратное смещение перехода, при котором он запирается. Особенностью работы транзистора является то, что при положительном смещении хотя бы одного перехода, общая область, называемая базой, насыщается электронами, или электронными вакансиями (в зависимости от типа проводимости материала базы), что обуславливает значительное снижение потенциального барьера второго перехода и как следствие, его проводимость при обратном смещении.
Режимы работы
Все схемы включения транзистора можно разделить на два вида: нормальную и инверсную .
Рисунок 3.
Нормальная схема включения транзистора предполагает изменение электрической проводимости коллекторного перехода путём управления смещением эмиттерного перехода.
Инверсная схема , в противоположность нормальной, позволяет управлять проводимостью эмиттерного перехода посредством управления смещением коллекторного. Инверсная схема является симметричным аналогом нормальной, но в виду конструктивной асимметрии биполярного транзистора малоэффективна для применения, имеет более жёсткие ограничения по максимально допустимым параметрам и практически не используется.
При любой схеме включения транзистор может работать в трёх режимах: Режим отсечки , активный режим и режим насыщения .
Для описания работы направление электрического тока в данной статье условно принято за направление электронов, т.е. от отрицательного полюса источника питания к положительному. Воспользуемся для этого схемой на рисунке 4.
Рисунок 4.
Режим отсечки
Для p-n перехода существует значение минимального напряжения прямого смещения, при котором электроны способны преодолеть потенциальный барьер этого перехода. То есть, при напряжении прямого смещения до этой пороговой величины через переход не может протекать ток. Для кремниевых транзисторов величина такого порога равна примерно 0,6 В. Таким образом, при нормальной схеме включения, когда прямое смещение эмиттерного перехода не превышает 0,6 В (для кремниевых транзисторов), ток через базу не протекает, она не насыщается электронами, и как следствие отсутствует эмиссия электронов базы в область коллектора, т.е. ток коллектора отсутствует (равен нулю).
Таким образом, для режима отсечки необходимым условием являются тождества:
U БЭ
I Б =0
Активный режим
В активном режиме эмиттерный переход смещается в прямом направлении до момента отпирания (начала протекания тока) напряжением больше 0,6 В (для кремниевых транзисторов), а коллекторный – в обратном. Если база обладает проводимостью p-типа, происходит перенос (инжекция) электронов из эмиттера в базу, которые моментально распределяются в тонком слое базы и почти все достигают границы коллектора. Насыщение базы электронами приводит к значительному уменьшению размеров коллекторного перехода, через который электроны под действием отрицательного потенциала со стороны эмиттера и базы вытесняются в область коллектора, стекая через вывод коллектора, обуславливая тем самым ток коллектора. Очень тонкий слой базы ограничивает её максимальный ток, проходящий через очень малое сечение поперечного разреза в направлении вывода базы. Но эта малая толщина базы обуславливает её быстрое насыщение электронами. Площадь переходов имеет значительные размеры, что создаёт условия для протекания значительного тока эмиттер-коллектор, в десятки и сотни раз превышающий ток базы. Таким образом, пропуская через базу незначительные токи, мы можем создавать условия для прохождения через коллектор токов гораздо большей величины. Чем больше ток базы, тем больше её насыщение, и тем больше ток коллектора. Такой режим позволяет плавно управлять (регулировать) проводимостью коллекторного перехода соответствующим изменением (регулированием) тока базы. Это свойство активного режима транзистора используется в схемах различных усилителей.
В активном режиме ток эмиттера транзистора складывается из тока базы и коллектора:
I Э = I К + I Б
Ток коллектора можно выразить соотношением:
I К = α I Э
где α – коэффициент передачи тока эмиттера
Из приведённых равенств можно получить следующее:
где β – коэффициент усиления тока базы.
Режим насыщения
Предел увеличения тока базы до момента, когда ток коллектора остаётся неизменным определяет точку максимального насыщения базы электронами. Дальнейшее увеличение тока базы не будет изменять степень её насыщения, и ни как не будет влиять на ток коллектора, может привести к перегреву материала в области контакта базы и выходу транзистора из строя. В справочных данных на транзисторы могут быть указаны величины тока насыщения и максимально допустимого тока базы, либо напряжения насыщения эмиттер-база и максимально допустимого напряжения эмиттер-база. Эти пределы определяют режим насыщения транзистора при нормальных условиях его работы.
Режим отсечки и режим насыщения эффективны при работе транзисторов в качестве электронных ключей для коммутации сигнальных и силовых цепей.
Отличие в принципе работы транзисторов с различными структурами
Выше был рассмотрен случай работы транзистора n-p-n структуры. Транзисторы p-n-p структуры работают аналогично, но есть принципиальные отличия, которые следует знать. Полупроводниковый материал с акцепторной проводимостью p-типа обладает сравнительно низкой пропускной способностью электронов, так как основан на принципе перехода электрона от одного вакантного места (дырки) к другому. Когда все вакансии замещены электронами, то их движение возможно только по мере появления вакансий со стороны направления движения. При значительной протяжённости участка такого материала он будет обладать значительным электрическим сопротивлением, что приводит к большим проблемам при его использовании в качестве наиболее массивных коллекторе и эмиттере биполярных транзисторов p-n-p типа, чем при использовании в очень тонком слое базы транзисторов n-p-n типа. Полупроводниковый материал с донорной проводимостью n-типа обладает электрическими свойствами проводящих металлов, что делает его более выгодным для использования в качестве эмиттера и коллектора, как в транзисторах n-p-n типа.
Эта отличительная особенность различных структур биполярных транзисторов приводит к большим затруднениям при производстве пар компонент с различными структурами и аналогичными друг другу электрическими характеристиками. Если обратить внимание на справочные данные характеристик пар транзисторов, можно заметить, что при достижении одинаковых характеристик двух транзисторов различных типов, например КТ315А и КТ361А, несмотря на их одинаковую мощность коллектора (150 мВт) и примерно одинаковый коэффициент усиления по току (20-90), у них отличаются максимально допустимые токи коллектора, напряжения эмиттер-база и пр.
P.S. Данное описание принципа действия транзистора было интерпретировано с позиции Русской Теории , поэтому здесь нет описания действия электрических полей на вымышленные положительные и отрицательные заряды. Русская Физика даёт возможность пользоваться более простыми, понятными механическими моделями, наиболее приближенными к действительности, чем абстракции в виде электрических и магнитных полей, положительных и электрических зарядов, которые вероломно подсовывает нам традиционная школа. По этой причине не рекомендую без предварительного анализа и осмысления пользоваться изложенной теорией при подготовке к сдаче контрольных, курсовых и иных видов работ, Ваши преподаватели могут просто не принять инакомыслие, даже конкурентоспособное и вполне состоятельное с точки зрения здравого смысла и логики. Кроме того, с моей стороны это первая попытка описания работы полупроводникового прибора с позиции Русской Физики, может уточняться и дополняться в дальнейшем.
Первое, что приходит в голову, когда слышишь подобный вопрос, это рассказать об устройстве транзистора: p-n переходах, их объединении в трехслойную конструкцию и т.д. Физика полупроводников, если подходить к вопросу серьезно, достаточно сложна и требует хотя бы начальных знаний о квантовой физике. И это касается только вопроса методичности изложения, тогда как и сама квантовая физика, как, впрочем, и классическая теория электричества, порою не в состоянии ответить на все возникающие вопросы. В итоге, чаще приходится просить принять что-то на веру после обширных математических выкладок и многочисленных поясняющих рисунков, а это никак не способствует пониманию существа вопроса.
Но действительно ли спрашивающего интересует физика полупроводников? Кого-то, может быть, и интересует, но большая часть вопрошающих, как мне кажется, больше склонна получить ответ на другой вопрос: как осмысленно использовать транзистор в схемах?
Транзистор – один из наиболее употребительных активных элементов электронных схем. В последнее время схемы часто строятся с использованием микросхем, а подход к их созданию требует только знания свойств и функциональных возможностей микросхемы, но следует забывать, что и свойства и функциональные возможности микросхемы обусловлены свойствами скрытых в ней компонент, где транзисторы продолжают играть значительную роль. Так что вопрос о работе транзистора не утратил актуальности. Но с учетом «микросхемного» подхода к созданию устройств рассмотрение свойств и функциональных возможностей транзисторов мне кажется более актуальным, чем физических принципов, лежащих в основе их работы, особенно для любителей.
Чаще всего транзистор используется для усиления сигнала. И хотя сигналы бывают разные, наиболее простые эксперименты можно осуществить с усилением синусоидального сигнала. А Proteus предоставляет все необходимое для этого.
В одном из весьма аргументированных сообщений, встреченных мною на форуме, где обсуждалась работа с Proteus, говорилось, что эта среда разработки предназначена для работы с цифровой техникой и микроконтроллерами, поэтому аналоговые схемы в ней исследовать нет резона. Меня заинтересовало, можно ли рассказать о применении транзисторов с помощью программы Proteus? Попробую это сделать.
Итак. Усиление сигнала можно рассматривать как усиление сигнала по току, усиление по напряжению и усиление по мощности. Усиление сигнала по току у транзистора обусловлено его свойством – ток коллектора и ток базы связаны соотношением Iк = К*Iб . При этом, если ток базы изменяется по какому-то закону, то ток коллектора изменяется по тому же закону, то есть, соотношение выше можно рассматривать для каждого момента времени. Вот, собственно, что я посчитал бы необходимым ответить на вопрос о том, как работает транзистор.
При работе с симметричными сигналами транзистор, как правило, включают так, чтобы напряжение на коллекторе было равно половине напряжения питания. В простейшем случае это достигается подбором резистора в цепи базы.
Рис. 3.1. Задание рабочего режима транзистора
Если в такой схеме менять величину сопротивления R1, что в Proteus достигается щелчком правой клавиши мышки по этому компоненту с последующим выбором из выпадающего меню пункта Edit Properties , открывающего, в свою очередь, диалоговое окно свойств резистора, где и задается величина сопротивления, так вот, если менять R1 то можно получить разное напряжение на коллекторе транзистора.
Однако гораздо полезнее подключить к схеме предыдущего рисунка генератор синусоидального напряжения, используя клавишу Generator Mode (иконка на левой инструментальной панели в виде кружка с синусоидой). Если теперь с помощью клавишиGraph Mode нарисовать график, можно выбратьANALOGUE из представленных возможностей, добавить пробник напряжения, обозначив его метку какoutput , то после настройки графика, в его свойствах я задаю время 10 мС (10m), так как я задал для генератора синусоиды 10 мВ (10m RMS) и частоту 1 кГц (1k), добавить кривую для графика, используя пункт выпадающего менюAdd Traces… , то теперь можно наблюдать выходной сигнал после запуска симуляции в пункте выпадающего менюSimulate Graph при разных значениях сопротивления, чтобы оценить, как влияет выбор рабочей точки на получающийся результат.
Рис. 3.2. Наблюдение синусоидального сигнала на коллекторе транзистора
Зачем на входе транзистора конденсатор? Чтобы сопротивление генератора, а генератор имеет некоторое внутреннее сопротивление, не меняло заданный режим. Конденсатор не пропускает постоянный ток, значит не изменит наших настроек. Можно включать разные источники сигнала, можно менять сопротивление в цепи коллектора, можно наблюдать многое в программе Proteus, и можно проверить, действительно ли между током базы и током коллектора есть соотношение, о котором было сказано в самом начале, и можно проверить, действительно ли ток (ток, а не напряжение, как у меня) коллектора повторяет закон изменения тока базы. Кстати, можно проверить и фазовые соотношения между напряжениями на базе транзистора и напряжением на его коллекторе. Это удобно сделать добавив второй график для сигнала input на рис.3.2.
Я же хочу проделать другие испытания. Если верить рассказам о Proteus, которые я нашел
в Интернете, то работа усилителя не зависит от того, какой транзистор вы используете. Выбирая разные транзисторы из библиотеки компонентов, я хочу посмотреть на амплитудночастотные характеристики получающихся усилителей. Для этой цели я использую ту же схему, добавлю в свой набор некоторое количество транзисторов, затем, меняя транзисторы, посмотрю, действительно ли их АЧХ одинаковы?
Рис. 3.3. Испытания разных транзисторов в Proteus
Для транзистора AC127, как это видно из графика, частота среза примерно 5 МГц. Похоже ли это на правду? Не хочу заниматься расчетами, но если современные транзисторы малой мощности имеют граничную частоту при включении с общей базой порядка 300 МГц, а усиление около 100, то граничная частота должна получиться около 3 МГц.
Когда рассказывают о строении биполярного транзистора, то обязательно упоминают о том, что он имеет две пограничные области на стыке полупроводников разных типов проводимости, очень напоминающие по свойствам заряженные конденсаторы. Этому свойству транзистор обязан своим поведением при усилении сигналов разных частот. Его поведение можно моделировать используя RC цепь. Амплитудно-частотная характеристика интегрирующей RC цепи и однокаскадного усилителя на транзисторе будут обладать одинаковыми свойствами. Можно сравнить графики рис. 1.14 и предыдущего, чтобы увидеть наличие верхней граничной частоты в обоих случаях и спада амплитудно-частотной характеристики со скоростью 20 дБ на декаду. Величина эквивалентного конденсатора зависит от конкретной модели транзистора. Если заменить одну модель транзистора другой, то можно ожидать, что амплитудно-частотная характеристика каскада изменится, если, конечно, у них различается такой параметр, как граничная частота усиления.
Поэтому я хочу заменить транзистор на TIP31.
Рис. 3.4. Амплитудно-частотная характеристика после замены транзистора
Не знаю, как у вас, а у меня верхняя граничная частота «улетела» за 10 МГц. Не уверен я теперь, что Proteus не годится для аналогового симулирования схем. Чтобы развеять свои сомнения я верну транзистор AC127, а в цепь эмиттера включу резистор. Этот резистор, удобнее рассмотреть его работу в схеме рис.3.1, приведет к тому, что напряжение базаэмиттер транзистора изменится. На нем будет падать напряжение, которое нужно вычесть из напряжения между базой и общим проводом, чтобы получить напряжение база-эмиттер. Входным напряжением для транзистора служит именно напряжение база-эмиттер. Таким образом, резистор в цепи эмиттера уменьшает входной сигнал для транзистора. Он, резистор, является резистором обратной связи – мы часть выходного сигнала (а на резисторе в цепи эмиттера в значительной мере сказывается именно выходной сигнал) сложили с учетом фазы со входным сигналом, дополнение «с учетом фазы» в данном случае указывает на то, что обратная связь будет отрицательной. А, насколько я знаю, отрицательная обратная связь должна расширить диапазон рабочих частот каскада усиления, то есть, верхняя граничная частота должна увеличится. Проверим, так ли это?
Рис. 3.5. Амплитудно-частотная характеристика с отрицательной обратной связью
Нисколько я не развеял сомнения, верхняя частота среза каскада вновь оказывается за 10 МГц, как и предписывает ей теория и практика. Видимо профессионалов не устраивает точность моделирования сравнительно с расчетами или практическим выполнением схем, но в любительской практике, если проверять результаты моделирования на макетной плате, программа окажется достойным помощником.
Проведем еще один эксперимент, который отчасти отвечает на вопрос о применимости Proteus к аналоговым схемам, отчасти на вопрос о том, как работает транзистор?
В самом начале я говорил, что ток базы и ток коллектора связаны соотношением, но никак не назвал это соотношение. Коэффициент «К» – это статический коэффициент усиления по току. Можно встретить его в виде Вст и в виде h31 . Это связь между постоянным током базы и коллектора. Но при работе транзистора в схеме нас больше может заинтересовать динамическая связь этих токов. Посмотрим, может ли Proteus помочь нам в этом.
Но предварительно, поскольку мы этого не сделали, найдем этот самый статический коэффициент усиления по току, как отношение постоянного тока коллектора к току базы в выбранном режиме. В схеме рис.3.1 я добавлю два измерителя тока, амперметра, один в цепь базы, другой в цепь коллектора. В свойствах этих амперметров (правый щелчок, в выпадающем меню свойства, затем окошко Display Range ) я заменю тот, что в цепи базы на микроамперметр, а в цепи коллектора на миллиамперметр.
Рис. 3.6. Измерение статического коэффициента усиления по току
Теперь можно разделить 5.67 мА на 22.6 мкА, что даст значение коэффициента, примерно, 250.
Мне хотелось бы проделать нечто подобное со входным и выходным током схемы на рис. 3.4. Токовый пробник к входной цепи добавляется и графика работает, а вот графика, если добавить токовый пробник в коллекторную цепь, работать не хочет. Но это не слишком огорчает меня, поскольку токовый пробник в общей цепи вполне меня устроит, ток в общей цепи – сумма токов базы и коллектора, но ток базы много меньше тока коллектора, так что для ориентировочных расчетов можно взять их сумму.
Можно, конечно, попытаться разобраться, отчего не хочет симулироваться график, если токовый пробник устанавливать в цепь коллектора. К этой проблеме можно вернуться позже, либо не рассматривать это в качестве проблемы до того момента, когда в таком измерении возникнет жестокая необходимость. Пока можно обойтись тем, что есть.
В общем рабочем поле графики немного маловаты, и если это, как мне в данном случае, мешает определить величины, можно выбрать из выпадающего меню после щелчка правой клавиши мышки по графику пункт Maximize (Show Window) , что приведет к появлению окна просмотра с большим графиком.
Рис. 3.7. Токи во входной и выходной цепях усилителя
Самый верхний график показывает напряжение сигнала на коллекторе транзистора. В окне просмотра легко выясняется, что двойная амплитуда сигнала около 8.5 – 3.5 = 5 В. Соответственно амплитуда должна быть 2.5 В. Прав я или нет, но при сопротивлении нагрузки равном 1 кОм ток через это сопротивление должен быть 2.5 мА.
Следующий график показывает токовый сигнал базы транзистора, двойная амплитуда которого 24 мкА, а амплитуда 12 мкА.
Последний график – это общий токовый сигнал, как алгебраическая сумма базового и коллекторного токов, который я, ничтоже сумняшеся, принимаю за выходной ток с амплитудой 2.5 мА. В этом случае усиление по току, как простое отношение выходного тока ко входному, будет около 208. Это близко к статическому коэффициенту усиления по току. Кроме того, зная, что входной сигнал равен 10 мВ (RSM) эффективного значения или 14 мВ амплитудного, а выходной сигнал 2.5 В, можно получить усиление по напряжению около 178. Это значение, выраженное в децибелах, дает величину 45 дБ. Это же значение присутствует на амплитудно-частотной характеристике этой схемы. Расчетное значение усиления по напряжению получается около 200. Пока похоже.
В одном из справочников приводится расчетное значение усиления по напряжению как отношение величины сопротивления в коллекторной и эмиттерной цепи для рис. 3.5. В данном случае это будет 1000/300 = 3.3 или в децибелах 20log(3.3) = 10.4. Это значение присутствует на амплитудно-частотной характеристике.
Что ж, был бы рад сказать, что убедился, с аналоговыми схемами работать нельзя, но не убедился пока. Увы!
Транзистором называется полупроводниковый прибор, предназначенный для усиления и генерирования электрических колебаний. Так что же такое транзистор ? – Он представляет собой кристалл, помещенный в корпус, снабженный выводами. Кристалл изготовляют из полупроводникового материала. По своим электрическим свойствам полупроводники занимают некоторое промежуточное положение между проводниками и непроводниками тока (изоляторами).
Небольшой кристалл полупроводникового материала (полупроводника) после соответствующей технологической обработки становится способным менять свою электропроводность в очень широких пределах при подведении к нему слабых электрических колебаний и постоянного напряжения смещения.
Кристалл помещают в металлический или пластмассовый корпус и снабжают тремя выводами, жесткими или мягкими, присоединенными к соответствующим зонам кристалла. Металлический корпус иногда имеет собственный вывод, но чаща с корпусом соединяют один из трех электродов транзистора.
В настоящее время находят применение транзисторы двух видов — биполярные и полевые . Биполярные транзисторы появились первыми и получили наибольшее распространение. Поэтому обычно их называют просто транзисторами. Полевые транзисторы появились позже и пока используются реже биполярных.
Быполярные транзисторы
Биполярными транзисторы называют потому, что электрический ток в них образуют электрические заряды положительной и отрицательной полярности. Носители положительных зарядов принято называть дырками, отрицательные заряды переносятся электронами. В биполярном транзисторе используют кристалл из германия или кремния — основных полупроводниковых материалов, применяемых для изготовления транзисторов и диодов.
Поэтому и транзисторы называют одни кремниевыми , другие – германиевыми . Для обоих разновидностей биполярных транзисторов характерны свои особенности, которые обычно учитывают при проектировании устройств.
Для изготовления кристалла используют сверхчистый материал, в который добавляют специальные строго дозированные; примеси. Они и определяют появление в кристалле проводимости, обусловленной дырками (р-проводимость) или электронами (n-проводимость). Таким образом формируют один из электродов транзистора, называемый базой.
Если теперь в поверхность кристалла базы ввести тем или иным технологическим способом специальные примеси, изменяющие тип проводимости базы на обратную так, чтобы образовались близколежащие зоны n-р-n или р-n-р, и к каждой зоне подключить выводы, образуется транзистор.
Одну из крайних зон называют эмиттером, т. е. источником носителей заряда, а вторую — коллектором, собирателем этих носителей. Зона между эмиттером и коллектором называется базой. Выводам транзистора обычно присваивают названия, аналогичные его электродам.
Усилительные свойства транзистора проявляются в том, что если теперь к эмиттеру и базе приложить малое электрическое напряжение — входной сигнал, то в цепи коллектор — эмиттер потечет ток, по форме повторяющий входной ток входного сигнала между базой и эмиттером, но во много раз больший по значению.
Для нормальной работы транзистора в первую очередь необходимо подать на его электроды напряжение питания. При этом напряжение на базе относительно эмиттера (это напряжение часто называют напряжением смещения) должно быть равно нескольким десятым долям вольта, а на коллекторе относительно эмиттера — несколько вольт.
Включение в цепь n-р-n и р-n-р транзисторов отличается только полярностью напряжения на коллекторе и смещения. Кремниевые и германиевые транзисторы одной и той же структуры отличаются между собой лишь значением напряжения смещения. У кремниевых оно примерно на 0,45 В больше, чем у герма ниевых.
Рис. 1
На рис. 1 показаны условные графические обозначения транзисторов той и другой структуры, выполненных на основе германия и кремния, и типовое напряжение смещения. Электроды транзисторов обозначены первыми буквами слов: эмиттер — Э, база — Б, коллектор — К.
Напряжение смещения (или, как принято говорить, режим) показано относительно эмиттера, но на практике напряжение на электродах транзистора указывают относительно общего провода устройства. Общим проводом в устройстве и на схеме называют провод, гальванически соединенный с входом, выходом и часто с источником питания, т. е. общий для входа, выхода и источника питания.
Усилительные и другие свойства транзисторов характеризуются рядом электрических параметров, наиболее важные из которых рассмотрены ниже.
Статический коэффициент передачи тока базы h 21Э показывает, во сколько раз ток коллектора биполярного транзистора больше тока его базы, вызвавшего этот ток. У большинства типов транзисторов численное значение этого коэффициента от экземпляра к экземпляру может изменяться от 20 до 200. Есть транзисторы и с меньшим значением — 10…15, и с большим — до 50…800 (такие называют транзисторами со сверхусилением).
Нередко считают, что хорошие результаты можно получить только с транзисторами, имеющими большое значение h 21э. Однако практика показывает, что при умелом конструировании аппаратуры вполне можно обойтись транзисторами, имеющими h 2 l Э, равный всего 12…20. Примером этого может служить большинство конструкций, описанных в этой книге.
Частотными свойствами транзистора учитывается тот факт, что транзистор способен усиливать электрические сигналы с частотой, не превышающей определенного для каждого транзистора предела. Частоту, на которой транзистор теряет свои усилительные свойства, называют предельной частотой усиления транзистора.
Для того, чтобы транзистор мог обеспечить значительное усиление сигнала, необходимо, чтобы максимальная рабочая частота сигнала была по крайней мере в 10…20 раз меньше предельной частоты f т транзистора. Например, для эффективного усиления сигналов низкой частоты (до 20 кГц) применяют низкочастотные транзисторы, предельная частота которых не менее 0,2…0,4 МГц.
Для усиления сигналов радиостанций длинноволнового и средневолнового диапазонов волн (частота сигнала не выше 1,6 МГц) пригодны лишь высокочастотные транзисторы с предельной частотой не ниже 16…30 МГц.
Максимальная допустимая рассеиваемая мощность — это наибольшая мощность, которую может рассеивать транзистор в течение длительного времени без опасности выхода из строя. В справочниках по транзисторам обычно указывают максимальную допустимую мощность коллектора Яктах, поскольку именно в цепи коллектор — эмиттер выделяется наибольшая мощность и действуют наибольшие ток и напряжение.
Базовый и коллекторный токи, протекая по кристаллу транзистора, разогревают его. Германиевый кристалл может нормально работать при температуре не более 80, а кремниевый — не более 120°С. Тепло, которое выделяется в кристалле, отводится в окружающую, среду через корпус транзистора, а также и через дополнительный теплоотвод (радиатор), которым дополнительно снабжают транзисторы большой мощности.
В зависимости от назначения выпускают транзисторы малой, средней и большой мощности. Маломощные используют главным образом для усиления и преобразования слабых сигналов низкой и высокой частот, мощные — в оконечных ступенях усиления и генерации электрических колебаний низкой и высокой частот.
Усилительные возможности ступени на биполярном транзисторе зависят не только от того, какой он мощности, а сколько от того, какой конкретно выбран транзистор, в каком режиме работы по переменному и постоянному току он работает (в частности, каковы ток коллектора и напряжение между коллектором и эмиттером), каково соотношение рабочей частоты сигнала и предельной частоты транзистора.
Что такое полевой транзистор
Полевой транзистор представляет собой полупроводниковый прибор, в котором управление током между двумя электродами, образованным направленным движением носителей заряда дырок или электронов, осуществляется электрическим полем, создаваемым напряжением на третьем электроде.
Электроды, между Которыми протекает управляемый ток, иоСят название истока и стока, причем истоком считают тот электрод, из которого выходят (истекают) носители заряда.
Третий, управляющий, электрод называют затвором. Токопроводящий участок полупроводникового материала между истоком и стоком принято называть каналом, отсюда еще одно название этих транзисторов — канальные. Под действием напряжения на затворе» относительно истока меняется сопротивление канала» а значит, и ток через него.
В зависимости от типа носителей заряда различают транзисторы с n-каналом или р-каналом . В n-канальных ток канала обусловлен направленным движением электронов, а р-канальных — дырок. В связи с этой особенностью полевых транзисторов их иногда называют также униполярными. Это название подчеркивает, что ток в них образуют носители только одного знака, что и отличает полевые транзисторы от биполярных.
Для изготовления полевых транзисторов используют главным образом кремний, что связано с особенностями технологии их производства.
Основные параметры полевых транзисторов
Крутизна входной характеристики S или проводимость прямой передачи тока Y 21 указывает, на сколько миллиампер изменяется ток канала при изменении входного напряжения между затвором и истоком на 1 В. Поэтому значение крутизны входной характеристики определяется в мА/В, так же как и крутизна характеристики радиоламп.
Современные полевые транзисторы имеют крутизну от десятых долей до десятков и даже сотен миллиампер на вольт. Очевидно, что чем больше крутизна, тем большее усиление может дать полевой транзистор. Но большим значениям крутизны соответствует большой ток канала.
Поэтому-на практике обычно выбирают такой ток канала, при котором, о одной стороны, достигается требуемое усиление, а с другой — обеспечивается необходимая экономичность в расходе тока.
Частотные свойства полевого транзистора, так же как и биполярного, характеризуются значением предельной частоты. Полевые транзисторы тоже делят на низкочастотные, среднечастотные и высокочастотные, и также для получения большого усиления максимальная частота сигнала должна быть по крайней мере в 10…20 раз меньше предельной частоты транзистора.
Максимальная допустимая постоянная рассеиваемая мощность полевого транзистора определяется точно так же, как и для биполярного. Промышленность выпускает полевые транзисторы малой, средней и большой мощности.
Для нормальной работы полевого транзистора на его электродах должно действовать постоянное напряжение начального смещения. Полярность напряжения смещения определяется типом канала (n или р), а значение этого напряжения — конкретным типом транзистора.
Здесь следует указать, что среди полевых транзисторов значительно больше разнообразие конструкций кристалла, чем среди биполярных. Наибольшее распространение в любительских конструкциях и в изделиях промышленного производства получили полевые транзисторы с так называемым встроенным каналом и р-n переходом.
Они неприхотливы в эксплуатации, работают в широких частотных пределах, обладают высоким входным сопротивлением, достигающим на низкой частоте нескольких мегаом, а на средней и высокой частотах — нескольких десятков или сотен килоом в зависимости от серии.
Для сравнения укажем, что биполярные транзисторы имеют значительно меньшее входное сопротивление, обычно близкое к 1…2 кОм, и лишь ступени на составном транзисторе могут иметь большее входное сопротивление. В этом со-состоит большое преимущество полевых транзисторов перед биполярными.
На рис. 2 показаны условные обозначения полевых транзисторов со встроенным каналом и р-n переходом, а также указаны и типовые значения напряжения смещения. Выводы обозначены в соответствии с первыми буквами названий электродов.
Характерно, что для транзисторов с р-каналом напряжение на стоке относительно истока должно быть отрицательным, а на затворе относительно истока — положительным, а для транзистора с n-каналом — наоборот.
В промышленной аппаратуре и реже в радиолюбительской находят также применение полевые транзисторы с изолированным затвором. Такие транзисторы имеют еще более высокое входное сопротивление, могут работать на очень высоких частотах. Но у них есть существенный недостаток — низкая электрическая прочность изолированного затвора.
Для его пробоя и выхода транзистора из строя вполне достаточно даже слабого заряда статического электричества, который всегда есть на теле человека, на одежде, на инструменте.
По этой причине выводы полевых транзисторов с изолированным затвором при хранении следует связывать вместе мягкой голой проволокой, при монтаже транзисторов руки и инструменты нужно «заземлять», используют и другие защитные мероприятия.
Литература: Васильев В.А. Приемники начинающего радиолюбителя (МРБ 1072).
Что означает название “транзистор”
Транзистор не сразу получил такое привычное название. Первоначально, по аналогии с ламповой техникой его называли полупроводниковым триодом . Современное название состоит из двух слов. Первое слово – «трансфер», (тут сразу вспоминается «трансформатор») означает передатчик, преобразователь, переносчик. А вторая половина слова напоминает слово «резистор», – деталь электрических схем, основное свойство которой электрическое сопротивление.
Именно это сопротивление встречается в законе Ома и многих других формулах электротехники. Поэтому слово «транзистор» можно растолковать, как преобразователь сопротивления. Примерно так же, как в гидравлике изменение потока жидкости регулируется задвижкой. У транзистора такая «задвижка» изменяет количество электрических зарядов, создающих электрический ток. Это изменение есть не что иное, как изменение внутреннего сопротивления полупроводникового прибора.
Усиление электрических сигналов
Наиболее распространенной операцией, которую выполняют транзисторы , является усиление электрических сигналов . Но это не совсем верное выражение, ведь слабый сигнал с микрофона таковым и остается.
Усиление также требуется в радиоприеме и телевидении: слабый сигнал с антенны мощностью в миллиардные доли ватта необходимо усилить до такой степени, чтобы получить звук или изображение на экране. А это уже мощности в несколько десятков, а в некоторых случаях и сотен ватт. Поэтому процесс усиления сводится к тому, чтобы с помощью дополнительных источников энергии, полученной от блока питания, получить мощную копию слабого входного сигнала. Другими словами маломощное входное воздействие управляет мощными потоками энергии.
Усиление в других областях техники и природе
Такие примеры можно найти не только в электрических схемах. Например, при нажатии педали газа увеличивается скорость автомобиля. При этом на педаль газа нажимать приходится не очень сильно – по сравнению с мощностью двигателя мощность нажатия на педаль ничтожна. Для уменьшения скорости педаль придется несколько отпустить, ослабить входное воздействие. В этой ситуации мощным источником энергии является бензин.
Такое же воздействие можно наблюдать и в гидравлике: на открытие электромагнитного клапана, например в станке, энергии, идет совсем немного. А давление масла на поршень механизма способно создать усилие в несколько тонн. Это усилие можно регулировать, если в маслопроводе предусмотреть регулируемую задвижку, как в обычном кухонном кране. Чуть прикрыл – давление упало, усилие снизилось. Если открыл побольше, то и нажим усилился.
На поворот задвижки тоже не требуется прилагать особых усилий. В данном случае внешним источником энергии является насосная станция станка. И подобных воздействий в природе и технике можно заметить великое множество. Но все-таки нас больше интересует транзистор, поэтому далее придется рассмотреть…
Усилители электрических сигналов
Биполярный транзистор с гетеропереходом (HBT)
Биполярный транзистор с гетеропереходом (HBT)
Биполярные транзисторы с гетеропереходом (HBT) представляют собой тип биполярных транзисторов, в которых эмиттерный переход обычно предполагает структуру гетероперехода, т. Е. Используется материал с широкополосным зазором в области эмиттера и узкой полосой – материалы зазора используются для области базы. Они составляют основу для использования различных полупроводниковых материалов как для эмиссионной, так и для коллекторной основы.Биполярный гетеропереходный транзистор, или H BT, привлек большое внимание благодаря своей способности использовать очень быстрые устройства и является одной из самых многообещающих технологий для использования в электронных устройствах. [Источники: 0, 1, 3, 5]
Поскольку биполярные транзисторы имеют материальную структуру, они могут создавать инверсные искажения коллекторного перехода. Предполагается, что биполярный транзистор не поврежден, а коэффициент усиления по току можно уменьшить без повреждения транзистора. При анализе и проектировании схем биполярных транзисторов следует отметить, что обратное смещение HBT (или любого другого транзистора с гетеропереходом) не может быть превышено.Обратные искажения не должны быть слишком большими, иначе токи будут слишком высокими, а коэффициент усиления по току будет слишком низким, что приведет к повреждению транзистора. [Источники: 1]
Если соединение эмиттера биполярного транзистора имеет обратное смещение, которое превышает допустимый диапазон, но не ограничивает ток через транзистор, может произойти лавина, не повредив устройство. Если отверстия не начнут выходить из базы, напряжение насыщения будет ниже, чем у биполярных транзисторов с гомопереходом, и напряжение будет подаваться как на базу, так и на эмиттер.[Источники: 1, 5]
Для повышения плотности интеграции в транзисторах с гетеропереходом был предложен затвор I2-L. Это изобретение направлено против энергетической зоны гетеропереходов, на которую влияет выбор самого материала. Обычно это связано с тем, что такие гетеропереходные транзисторы имеют градуированную запрещенную зону, которая может находиться между базой эмиттера и коллектором. [Источники: 2, 3, 5]
Если два PN перехода биполярного транзистора смещены в прямом направлении, транзистор находится в области отсечки, а не в области насыщения.Однако, если биполярные транзисторы смещены назад (смещены вперед), транзисторы также выходят за пределы диапазона насыщения, а в диапазонах насыщения верно обратное. [Источники: 1]
Если поменять местами напряжения смещения, упомянутые выше, биполярные транзисторы работают как в диапазоне отсечки, так и в диапазоне насыщения. [Источники: 1]
В аналоговых устройствах на параметры биполярного транзистора влияет параметр биполярных транзисторов, но в разной степени. Эти параметры могут учитывать эффект Тивари [11] и мягкое перегибание, наблюдаемое в случае ISB – NB, которые учитываются с помощью тепловой эквивалентной схемы, смоделированной на основе теплового эволюционного уравнения, как показано в модели AgilentHBT [ 12].Поскольку «мягкое колено» служит основой для расчета ISB и NB, мы можем использовать те же параметры, что и аналоговое устройство, такие как температура, напряжение, насыщение и отсечка. [Источники: 1, 4]
Электрический символ биполярного транзистора NPN показан справа, а переход пучка базы и переход коллектора находятся в состоянии прямого смещения, в то время как точка сбора коллектора базы находится в состоянии смещения назад. В условном обозначении биполярных транзисторов стрелка у «базы» или «эмиттера» указывает направление тока.Стрелка в «базе» (отправитель) указывает на радиаторы, а в «коллекторе» стрелки у основания и радиаторов указывают на токи. В результате их напряжение ниже, чем у биполярных транзисторов, что позволяет рассчитывать их выходные напряжения и прерывания в аналоговом устройстве. [Источники: 1, 3]
Следовательно, биполярные транзисторы следует отличать от NPN-транзисторов с их двумя PN переходами и обратными напряжениями смещения. Поскольку биполярные транзисторы имеют два PN-транзистора, их обратное напряжение смещения может быть достаточным для предотвращения обратного пробоя P-N перехода.[Источники: 1]
Биполярный транзистор состоит из трех различных легированных полупроводниковых областей, которые определяются как верхняя, нижняя и специфичные для коллектора области биполярного транзистора PNP. Область общего коллектора интегрирована в нижнюю область, при этом транзистор работает как эмиттер верхнего типа. Биполярный транзистор состоит из одного PN-транзистора с тремя легирующими полупроводниками, каждый из которых отвечает за один из двух своих переходов и обратное напряжение смещения.В дополнение к двум областям легирования (вверху и внизу), P-NPipolar транзистор также состоит из второй зоны легирования (внизу) с его обратным напряжением смещения и обратным напряжением смещения. [Источники: 1, 3]
Как упоминалось выше, биполярный транзистор с гетеропереходом, который имеет два транзистора, один для проводящей полосы, а другой для полосы приемопередатчика, описывается как транзистор PNP. Следует понимать, что это изобретение не могло быть реализовано, потому что валентные зоны были бы выровнены и не было бы разницы в зонах проводимости.Если база коллектора полярного транзистора рассматривается как вход, двухпортовая сеть может быть проанализирована с помощью теоремы Тевенина. [Источники: 1, 5]
Источники:
[0]: https://www.nrl.navy.mil/estd/branches/6870/6876/HBT
[2]: https://www.google.com.na/patents/ US4794440
[3]: https://www.google.com/patents/US5329145
[4]: http: //literature.cdn.keysight.com / litweb / pdf / ads2008 / ccnld / ads2008 / AgilentHBT_Model_ (Agilent_Heterojunction_Bipolar_Transistor_Model) .html
[5]: https://www.google.com.gi/patents/US4821082
Переходные транзисторы | Altium
Александр Тамари| & nbsp Создано: 21 февраля 2017 г. & nbsp | & nbsp Обновлено: 6 октября 2020 г.
Даже если вы не инженер-электрик, скорее всего, вы все еще любите технологии и все, что они предлагают, будь то работа или отдых.Мы все оказываемся втянутыми в шум, когда выходит новый процессор, и слышим о том, как Intel использует 14-нм (нанометровую) технологию и имеет более миллиарда графеновых транзисторов. Но что это за технология и для какого устройства?
Назад к основам
Каким бы сложным ни был мир инженерии, понять, что такое транзистор, может быть удивительно просто. Это просто переключатель, который пропускает ток через него или нет. Говоря цифровым языком, это переводится как 1 или 0, включен или выключен.
Это постоянное колебание между включенным и выключенным состоянием того, что питает современные компьютеры, включая все ваши игры, оборудование и все остальное, что взаимодействует с процессом. Но это понимание – только начало того, что составляет скрытый мир этой технологии. Давайте погрузимся глубже.
FET – Полевой транзистор
Полевой транзистор состоит из трех основных компонентов – затвора, стока и источника. Когда напряжение добавляется к затвору, он создает путь в виде электрического поля для движения электронов (также известный как ток).MOSFET или Metal Oxide Semiconductor FET являются наиболее популярными типами, поскольку они имеют высокое входное сопротивление и низкое выходное сопротивление. А поскольку они управляются напряжением, они намного быстрее, чем их братья BJT с регулируемым током, что делает их идеальными для логики.
BJT – Транзистор биполярный
Биполярный переходной транзистор также состоит из трех основных частей – базы, эмиттера и коллектора. Когда к базе подается небольшой ток, через нее может протекать больший ток.Существует два типа BJT – NPN и PNP, где N и P относятся к полупроводникам N-типа и P-типа. В полупроводниках N-типа в качестве основного носителя используются электроны, а в полупроводниках P-типа используются дырки.
Рождение и рост транзистора
Транзистор был изобретен Уильямом Шокли, Уолтером Хаузером Браттейном и Джоном Бардином, которые работали в Bell Labs еще в 1947 году. Это изобретение является одним из самых важных в истории человечества и является рождением современной технологии.
Первый транзистор (Изображение предоставлено beatriceco) Технологияразвивается быстро, и от первого транзистора в 1947 году мы быстро перешли к первому интегрированному (IC) в 1958 году, а затем к первому микропроцессору в 1971 году. Первым микропроцессором был Intel ® 4004, который содержал 2300 транзисторов и был первым микропроцессором. размером с маленький ноготь. Отсюда у нас есть только улучшение устройства. Скорее всего, вы слышали о законе Мура, но давайте просто быстро перефразируем:
«Количество различных транзисторов, встроенных в микросхему, будет примерно удваиваться каждые 24 месяца.”
Хронология закона Мура (изображение любезно предоставлено techspot)Из приведенной выше инфографики видно, что мы уменьшали размер транзистора с момента его создания. Но, похоже, в последнее время мы стоим на месте. Мы все еще можем стать меньше, но мы приближаемся к физическому пределу. Возможно, вы слышали об окончании кремниевых и кремниевых транзисторов, но это тема для другого дня.
Нам удалось улучшить и увеличить их количество, продвигаясь вверх, а не уходя.Современные процессоры перешли от двухмерных планарных триггерных транзисторов к трехмерным. Intel представила их в своей 22-нм технологии. Благодаря этим новым достижениям процессоры стали быстрее и в то же время потребляют гораздо меньше энергии, что отлично подходит для мобильных устройств.
2D Planar (слева) и 3D Trigate Transistor (справа) (Изображение любезно предоставлено Intel)Что принесет будущее
Хотя может показаться, что процесс миниатюризации транзисторов замедляется, это не означает, что для транзисторов наступает конец.Как однажды сказал соучредитель Intel Гордон Мур: «Все, что можно сделать, можно превзойти». Этот принцип как никогда актуален для проектирования электроники, поскольку мы движемся в будущее, связанное с подключением, где повседневные продукты разрабатываются с новым уровнем автоматизации, интеллекта и гибкости. В основе этого изменения лежит Altium Designer ® , который поддерживает самые передовые на сегодняшний день высокоскоростные конструкции и жесткие и гибкие технологии.
Оцените Altium Designer в действии…
Мощный дизайн печатной платы
Произошла ошибка при настройке пользовательского файла cookie
Этот сайт использует файлы cookie для повышения производительности. Если ваш браузер не принимает файлы cookie, вы не можете просматривать этот сайт.
Настройка вашего браузера для приема файлов cookie
Существует множество причин, по которым cookie не может быть установлен правильно. Ниже приведены наиболее частые причины:
- В вашем браузере отключены файлы cookie.Вам необходимо сбросить настройки своего браузера, чтобы он принимал файлы cookie, или чтобы спросить вас, хотите ли вы принимать файлы cookie.
- Ваш браузер спрашивает вас, хотите ли вы принимать файлы cookie, и вы отказались. Чтобы принять файлы cookie с этого сайта, нажмите кнопку «Назад» и примите файлы cookie.
- Ваш браузер не поддерживает файлы cookie. Если вы подозреваете это, попробуйте другой браузер.
- Дата на вашем компьютере в прошлом. Если часы вашего компьютера показывают дату до 1 января 1970 г., браузер автоматически забудет файл cookie.Чтобы исправить это, установите правильное время и дату на своем компьютере.
- Вы установили приложение, которое отслеживает или блокирует установку файлов cookie. Вы должны отключить приложение при входе в систему или проконсультироваться с системным администратором.
Почему этому сайту требуются файлы cookie?
Этот сайт использует файлы cookie для повышения производительности, запоминая, что вы вошли в систему, когда переходите со страницы на страницу. Чтобы предоставить доступ без файлов cookie потребует, чтобы сайт создавал новый сеанс для каждой посещаемой страницы, что замедляет работу системы до неприемлемого уровня.
Что сохраняется в файле cookie?
Этот сайт не хранит ничего, кроме автоматически сгенерированного идентификатора сеанса в cookie; никакая другая информация не фиксируется.
Как правило, в файлах cookie может храниться только информация, которую вы предоставляете, или выбор, который вы делаете при посещении веб-сайта. Например, сайт не может определить ваше имя электронной почты, пока вы не введете его. Разрешение веб-сайту создавать файлы cookie не дает этому или любому другому сайту доступа к остальной части вашего компьютера, и только сайт, который создал файл cookie, может его прочитать.
Магнитный биполярный транзистор на основе гетероструктуры ZnO / NiO / Si с использованием импульсного лазерного осаждения: AIP Advances: Том 10, № 1
ВВЕДЕНИЕ
Раздел:
ВыборВерх страницыАБРАКТУРА ВВЕДЕНИЕ << ЭКСПЕРИМЕНТАЛЬНЫЕ ДЕТАЛИ РЕЗУЛЬТАТОВ И ИХ ОБСУЖДЕНИЕМатериалы следующего поколения являются потенциальными кандидатами из-за их привилегированных свойств нулевой суммарной намагниченности, которая не приводит к полям рассеяния и не может подвергаться воздействию внешнего магнитного поля.В них отчетливо проявляются спин-орбитальные и магнитотранспортные эффекты, обусловленные собственной высокочастотной динамикой. Недавно он открывает план по анализу спиновых технологий с использованием этих новых концепций в антиферромагнетиках. Оксиды переходных металлов (TMO) привлекли большое внимание в исследовательских областях из-за их разнообразного потенциального технологического применения. 1–3 1. P. L. S. G. Poizot et al. , «Наноразмерные оксиды переходных металлов в качестве материалов отрицательных электродов для литий-ионных батарей», Nature 407 (6803), 496 (2000).https://doi.org/10.1038/350350452. Ю. Токура и Н. Нагаоса, “Орбитальная физика в оксидах переходных металлов”, Science 288 (5465), 462–468 (2000). https://doi.org/10.1126/science.288.5465.4623. П. А. Кокс, Оксиды переходных металлов: введение в их электронную структуру и свойства , Vol. 27, Oxford University Press, 2010. TMO, такие как ZnO и NiO, имеют дополнительные преимущества благодаря своим уникальным свойствам прозрачности и проводимости, которые делают их пригодными для различных применений в оптоэлектронике, светодиодах, солнечных элементах, газовых датчиках и тонкопленочных транзисторах. 4–10 4. К. Мацубара и др. , «Прозрачные проводящие пленки ZnO, осажденные импульсным лазерным осаждением для солнечных батарей», Тонкие твердые пленки 431 , 369–372 (2003). https://doi.org/10.1016/s0040-6090(03)00243-85. K. Wang et al. , «Прямой рост сильно рассогласованных массивов нанопроволок ZnO / ZnSe типа II / ZnSe типа II на прозрачных проводящих оксидных подложках для солнечных элементов», Advanced Materials 20 (17), 3248–3253 (2008). https: // doi.org / 10.1002 / adma.2008001456. M. Warasawa et al. , «Изготовление солнечных элементов, прозрачных для видимого света, с использованием пленок NiO p-типа методом высокочастотного распыления с низкой долей кислорода», Японский журнал прикладной физики 52 (2R), 021102 (2013). https://doi.org/10.7567/jjap.52.0211027. R. Karsthof et al. , «Полупрозрачные УФ фотоэлектрические элементы NiO / ZnO», Physica Status Solidi (A) 213 (1), 30–37 (2016). https://doi.org/10.1002/pssa.2015326258. Д.-Y. Son et al. , «Перовскитовый солнечный элемент с эффективностью 11% на основе наностержней ZnO: эффективная система сбора заряда», Журнал физической химии C 118 (30), 16567–16573 (2014). https://doi.org/10.1021/jp412407j9. L. Stolt et al. , «ZnO / CdS / CuInSe 2 тонкопленочные солнечные элементы с улучшенными характеристиками», Applied Physics Letters 62 (6), 597–599 (1993). https://doi.org/10.1063/1.10886710. F. Garnier et al. , «Органический« мягкий »тонкопленочный транзистор с очень высокой подвижностью носителей», Advanced Materials 2 (12), 592–594 (1990).https://doi.org/10.1002/adma.191207 NiO, который является антиферромагнитным материалом, является перспективным TMO p-типа с широкой запрещенной зоной 3,6–4 эВ и демонстрирует настраиваемые электрические свойства. Оксид цинка, который представляет собой полупроводник с широкой запрещенной зоной n-типа (E
g = 3,3 эВ), продемонстрировал потенциальные возможности применения во многих устройствах, таких как оптоэлектронные устройства, фотоэлектрическая энергия, спинтроника и датчики. 11,12 11. M. Godlewski et al. , «Оксид цинка для электронных, фотоэлектрических и оптоэлектронных приложений», Физика низких температур 37 (3), 235–240 (2011).https://doi.org/10.1063/1.357093012. F. Pan et al. , «Ферромагнетизм и возможное применение в спинтронике пленок ZnO, легированных переходными металлами», Материаловедение и инженерия: R: Reports 62 (1), 1–35 (2008). https://doi.org/10.1016/j.mser.2008.04.002 Биполярный переходной транзистор (BJT) имеет возможность управлять потоком тока между тремя выводами транзисторов, что позволяет им служить строительным блоком для различных логических устройств. , усилители и различные электронные устройства, такие как мобильные телефоны, телевизионные и радиопередатчики. 13,14 13. D. K. Nayak et al. , «Квантовая яма Ge / sub x / Si / sub 1-x / PMOS в режиме расширения», IEEE Electron Device Letters 12 (4), 154–156 (1991). https://doi.org/10.1109/55.7574814. I. Meric et al. , «Насыщение тока в полевых транзисторах с нулевой запрещенной зоной и верхним затвором на графеновых полевых транзисторах», Nature Nanotechnology, 3, (11), 654 (2008). https://doi.org/10.1038/nnano.2008.268 BJT обладают высокой управляемостью и могут работать на высоких частотах, что позволяет использовать их в прозрачных дисплеях, функциональных окнах или устройствах дополненной реальности.В настоящей работе биполярный транзистор NPN был изготовлен путем нанесения тонких пленок NiO p-типа и ZnO n-типа на кремниевую пластину n-типа с использованием технологии импульсного лазерного осаждения (PLD). Было доказано, что PLD является высокоэффективным и гибким методом осаждения различных металлов и оксидов, таких как ZnO и NiO. Были проведены и проанализированы структурные, оптические и магнитные свойства тонких пленок. Электрические свойства изготовленного устройства исследованы в диодном и транзисторном режимах.Различные параметры, такие как коэффициент идеальности (n), последовательное сопротивление (R S ) и q-точка, определялись стандартными методами.ЭКСПЕРИМЕНТАЛЬНЫЕ ДЕТАЛИ
Раздел:
ВыбратьВверх страницы РЕЗУЛЬТАТЫ ВВЕДЕНИЕ ЭКСПЕРИМЕНТАЛЬНЫЕ ДЕТАЛИ << РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ Тонкие пленки n-ZnO / p-NiO были выращены методом импульсного лазерного напыления 5 × 900 мм 2 n-ZnO / p-NiO на кремнии n-ZnO / p-NiO 2 вафля. Мишени NiO и ZnO использовались для формирования слоев NiO и ZnO, и во время осаждения энергия и частота импульсов лазера поддерживались на уровне 200 мДж и 10 Гц соответственно.Пленки осаждали в течение 10 минут при повышенной температуре 670 ° C. Во время напыления плотность энергии лазерного луча составляла 1,68 Дж / см 2 . Затем последовал шестичасовой отжиг при той же температуре 670 ° C. Температура роста и последующего отжига играет решающую роль для получения тонких пленок высокого качества, поскольку шероховатость поверхности значительно уменьшается при более высоких температурах. 15,16 15. T. D. Desissa et al. , «Взаимодиффузия через прямой p-n-гетеропереход NiO, легированного Li, и ZnO, легированного Al», Твердотельные ионные соединения.320 , 215–220 (2018). https://doi.org/10.1016/j.ssi.2018.03.01116. T. Rattana et al. , «Влияние температуры отжига на тонкие пленки гетероперехода NiO / ZnO, полученные золь-гель методом», Key Eng. Матер. 675-676 , 225–228 (2016). https://doi.org/10.4028/www.scientific.net/kem.675-676.225 Расстояние от подложки до мишени составляло 4 см, для NiO и ZnO было получено около 4000 выстрелов лазером. Базовое давление и давление кислорода поддерживались на уровне 6х10 -6 мбар и 0.1 мбар соответственно. Схема изготовленного устройства представлена на рис. 1 (А). Толщина базовой области NiO сохранялась намного меньше, чем область коллектора ZnO. Рентгеновский дифрактометр (XRD)Rigaku Miniflex был использован для исследования структурных свойств осажденных тонких пленок с использованием сканирования 2θ – θ с Cu-k α . Спектры комбинационного рассеяния регистрировали с помощью спектрометра комбинационного рассеяния Enspectr в диапазоне 300-1200 см -1 с использованием источника зеленого лазера мощностью 300 мВт и длиной волны 532 нм.Магнитные измерения наблюдали с помощью магнитометра с вибрирующим образцом (VSM) Cryogenic Ltd UK. Выходные ВАХ были измерены как для диода, так и для транзистора с помощью прецизионного источника / измерительного блока (SMU) KeysightB2902A.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Раздел:
ВыбратьВерх страницыАБРАКТА ВВЕДЕНИЕ ЭКСПЕРИМЕНТАЛЬНЫЕ ДЕТАЛИ РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ << ЗАКЛЮЧЕНИЕ ССЫЛКИ И ОБСУЖДЕНИЕ Фазообразование осажденных пленок NiO и ZnO было определено методом XRD. Инжир.1 (B) поясняет спектры XRD тонких пленок NiO и ZnO, нанесенных на подложку Si n-типа. Как видно из результатов, ZnO имеет предпочтительную ориентацию в направлении (002) и является высококристаллическим. С другой стороны, пленки NiO демонстрируют поликристаллическое поведение с преимущественной ориентацией в направлениях (111) и (200). 17 17. П. С. Патил и Л. Д. Кадам, «Приготовление и определение характеристик тонких пленок оксида никеля (NiO), подвергнутых распылительному пиролизу», Прикладная наука о поверхности, , 199, (1-4), 211–221 (2002).https://doi.org/10.1016/s0169-4332(02)00839-5 Спектры комбинационного рассеяния были получены с использованием рамановского спектрофотометра, в котором на образец фокусировался возбуждающий лазер с длиной волны 532 нм с линейно поляризованным лучом. Параллельный компонент поляризованного лазера был сфокусирован на подложке, поскольку перпендикулярная часть поляризованного лазера погасла. Поскольку NiO является антиферромагнитным материалом, с ним связаны магноны со спином вверх и вниз, которые будут зависеть от структуры NiO в основном состоянии.Рис. 1 (C) показывает, что пик комбинационного рассеяния NiO при 530 см -1 соответствует продольной оптике первого порядка (1P), а при 1090 см -1 – продольной оптике второго порядка (2P). Это связано с модой растяжения Ni-O и указывает на сильное фонон-магнонное взаимодействие при 530 см -1 . Точно так же для ZnO пик комбинационного рассеяния при 430 см -1 соответствует продольной оптике первого порядка и продольной оптике второго порядка при 1100 см -1 . 18–20 18.BS Yeo и AT Bell, « In situ Рамановское исследование оксида никеля и нанесенных золотом катализаторов на основе оксида никеля для электрохимического выделения кислорода», The Journal of Physical Chemistry C 116 (15), 8394–8400 (2012) . https://doi.org/10.1021/jp300741519. C. Bundesmann et al. , «Рамановское рассеяние света в тонких пленках ZnO, легированных Fe, Sb, Al, Ga и Li», Applied Physics Letters 83 (10), 1974–1976 (2003). https://doi.org/10.1063/1.160925120. X. L. Xu et al., «Тонкие поликристаллические пленки ZnO на Si (10 0), осажденные с помощью катодной вакуумной дуги с фильтром», Journal of Crystal Growth, 223 (1-2), 201–205 (2001). https://doi.org/10.1016/s0022-0248(01)00611-x Интенсивность пика 2P почти близка к пику 1P, что указывает на наличие некоторых недостатков в кристаллическом качестве тонкой пленки ZnO. Следовательно, спектроскопия комбинационного рассеяния дает дополнительную информацию о качестве кристаллической структуры и дефектах решетки, присутствующих в структуре устройства. 1 (D) показывает петлю магнитного гистерезиса гетероструктуры ZnO / NiO / Si с внешним магнитным полем, приложенным параллельно плоскости пленки.Из петли ясно, что ферромагнетизм присутствовал в изготовленном устройстве, что может быть связано с присутствием никелевых или кислородных вакансий в NiO, способствующих спиновой поляризации. 21,22 21. В. Верма и М. Катияр, «Происхождение собственного ферромагнетизма в нелегированных антиферромагнитных тонких пленках NiO», Journal of Physics D: Applied Physics 48 (23), 235003 (2015). https://doi.org/10.1088/0022-3727/48/23/23500322. Дж. Фабиан, И. Чутич и С. ДасСарма, «Магнитный биполярный транзистор», Applied Physics Letters 84 (1), 85–87 (2004).https://doi.org/10.1063/1.1637954 Коэрцитивная сила в плоскости оказалась равной 42 Э. Мы теоретически изучили влияние вакансии Ni или O в NiO с помощью теории функционала плотности (DFT) (рис. 2). Это показывает, что чистый NiO имеет антиферромагнитную природу, тогда как вакансия вызывает ферромагнетизм в NiO, что хорошо согласуется с предыдущим отчетом. 23 23. X. Wan, Y. Jiang, Z. Qiu, H. Zhang, X. Zhu, I. Sikandar, X. Liu, X. Chen и B. Cao, «Цинк как новая присадка для NiO. Планарные солнечные элементы на основе перовскита на основе x со стабильным КПД около 20%, ACS Applied Energy Materials 1 (8), 3947–3954 (2018).https://doi.org/10.1021/acsaem.8b00671 Однако магнитный момент (0,018μ B ) намного выше с очень маленькой вакансией Ni (∼3%). В то время как момент, генерируемый для вакансии ∼ 13% O, составляет около 0,0022μ B , что очень мало по сравнению с вакансией Ni. Электрические характеристики пленок NiO и ZnO, выращенных на Si-пластине, проводились при комнатной температуре. На рис. 3 (A и B) показаны ВАХ двух изготовленных диодов, т.е. p-NiO / n-Si и n-ZnO / p-NiO с прямым и обратным смещением.Очевидно, что изготовленное устройство демонстрирует характеристики диода, которые могут быть описаны физикой полупроводников. Ток в котором определяется следующим уравнением: где q – заряд электрона, В, – приложенное напряжение, к, – постоянная Больцмана, Т, – температура в Кельвинах, n – идеальность. коэффициент и I S – это обратный ток насыщения, протекающий через область обеднения, независимо от типа поляризации.Как правило, текущее уравнение моделируется следующим уравнением: 24 24. М. Халис, Р. Масрур, Ю. Мир и М. Зазуи, «Два метода определения параметров неидеального диода», Международный журнал физических наук 10 (8), 270–275 (2015). https://doi.org/10.5897/ijps2015.4260 где R S – последовательное сопротивление, более высокое значение которого отражает отклонение от идеального поведения диода. В T – kT / q – тепловое напряжение.Коэффициент идеальности для NiO / Si был получен равным n = 4,56 с использованием уравнения. (1) и последовательное сопротивление было получено R с = 0,066 МОм по формуле. (2). Аналогично, для перехода NiO / ZnO рассчитанные значения равны n, = 3,25 и Rs = 0,11 МОм. На рис. 3 (В – Г) показаны ВАХ изготовленных диодов для различных магнитных полей, приложенных перпендикулярно плоскости пленки. Из результатов видно, что напряжение на колене уменьшается с увеличением магнитного поля.Это указывает на индуцированный ферромагнетизм из вакансий Ni или кислорода в тонкой пленке NiO. В области прямого смещения при определенном приложенном напряжении ток увеличивается с увеличением магнитного поля. Мы объяснили вышеупомянутое поведение с помощью механизма спинового расщепления, как показано на рис. 3 (E и F). Рис. 3 (E) показывает схему спинового расщепления в магнитном поле. Из рис. 3 (F) видно, что при B → = 0, когда нет спинового расщепления, встроенный потенциал (Vbi) для уровней энергии со спином вверх и вниз относительно высок, что в основном дает низкий ток прямого смещения.Однако, когда спиновое расщепление увеличивается под действием магнитного поля (B → ≠ 0), Vbi для обоих спинов больше не остается таким же, как раньше. Например, Vbi + 1/2 значительно уменьшается, а Vbi-1/2 увеличивается по отношению к Vbi, как можно увидеть на рис. 3 (F). Это действительно снижает изгибное напряжение p-n-перехода и значительно увеличивает перенос электронов и дырок со спином вверх в условиях прямого смещения. 25 25. И. Зутич, Дж. Фабиан и С. С. Эрвин, «Биполярная спинтроника: от инжекции спина к логике, управляемой спином», J.Физ .: Конденс. Дело 19 , 165219 (2007). https://doi.org/10.1088/0953-8984/19/16/165219 Следовательно, общий ток увеличивается под действием магнитного поля. Из диаграммы энергетических зон также можно понять, что природа прямого тока смещения останется прежней, если мы просто перевернем магнитное поле (, например, H = -1400 Э). Таким образом, можно сделать вывод, что исследуемое устройство может быть использовано в качестве магнитно-настраиваемого полупроводникового устройства. В предлагаемом магнитном транзисторе использован прямой активный режим транзистора, при котором обедненный слой эмиттер-база смещен в прямом направлении, а переход база-коллектор имеет обратное смещение.На рис. 4 (A) показаны выходные характеристики изготовленного транзистора в конфигурации с общим эмиттером для различных приложенных токов смещения (I B ). При низком базовом токе сначала с увеличением выходного напряжения (V ce ) ток коллектора (I c ) увеличивается линейно, поскольку для низких напряжений переход не имеет обратного смещения. Когда питание увеличивается, переход база-коллектор становится смещенным в обратном направлении, и I c очень мало увеличивается с V ce и насыщается выходным напряжением. 26 26. M. Boll et al. , “Микроскопия антиферромагнитных корреляций в цепочках Ферми-Хаббарда с разрешением по спину и плотности”, Science 353 (6305), 1257–1260 (2016). https://doi.org/10.1126/science.aag1635 Таким образом, изготовленное устройство показывает характеристики транзистора, а q-точка находится в активной области при напряжении 2,17 В и токе коллектора 1,73 мкА. На рис. 4 (B) показаны характеристики выходного транзистора в зависимости от магнитного поля.Наблюдается, что с увеличением магнитного поля, как в +, так и в – направлениях, ток коллектора увеличивается, что можно объяснить присутствием ферромагнетизма из Ni или кислородных вакансий в тонкой пленке NiO в представленном транзисторе, как описано выше в случае характеристик диода. Таким образом, можно сделать вывод, что такие устройства могут быть использованы для будущих приложений спинтроники.Демонстрация сверхвысокоскоростных биполярных транзисторов с гетеропереходом – ScienceDaily
Imec реализовано на T / f MAX 245 ГГц / 450 ГГц SiGe: C гетеропереходный биполярный транзистор (HBT), ключевой фактор для будущего миллиметрового диапазона больших объемов маломощные схемы для использования в автомобильных радарах.Эти устройства HBT также открывают путь к кремниевым схемам миллиметрового диапазона, проникающим в так называемый ТГц промежуток, что позволяет использовать усовершенствованные системы визуализации для безопасности, медицинских и научных приложений.
Чрезвычайно быстродействующие устройства имеют полностью самовыравнивающуюся архитектуру за счет самовыравнивания области эмиттера, базы и коллектора и реализуют оптимизированный профиль легирования коллектора. По сравнению с устройствами III-V HBT, SiGe: C HBT сочетают в себе высокую плотность и низкую стоимость интеграции, что делает их пригодными для потребительских приложений.Такие высокоскоростные устройства могут открыть новые области применения, работая на очень высоких частотах с меньшим рассеянием мощности, или приложения, которые требуют меньшего воздействия процесса, колебаний напряжения и температуры на более низких частотах для повышения надежности схемы.
Для удовлетворения требований к сверхвысокой скорости современные SiGe: C HBT нуждаются в дальнейшем увеличении производительности устройства. Обычно считается, что профили легирования тонких субколлекторов являются обязательными для этого увеличения.Обычно коллекторные присадки вводятся в начале обработки и, таким образом, подвергаются полному тепловому балансу технологического потока. Это затрудняет точное позиционирование заглубленного коллектора. Путем легирования мышьяком in-situ во время одновременного роста подставки подколлектор и базы SiGe: C, imec ввел как тонкую, хорошо контролируемую, низколегированную область коллектора рядом с базой, так и резкий переход к высоколегированному коллектору без еще больше усложняя процесс.Это привело к значительному увеличению общей производительности устройства HBT: пиковые значения f MAX выше 450 ГГц получены на устройствах с высоким начальным напряжением, BV CEO на 1,7 В и резкий переход от насыщения к активной области. в выходной кривой I C -V CE . Несмотря на агрессивное масштабирование профиля легирования субколлектором, значения емкости коллектор-база не сильно увеличились. Более того, усиление по току хорошо определено, в среднем около 400, и туннельный ток эмиттер-база, видимый при низких значениях V BE , также ограничен.
Эти выдающиеся результаты были получены в рамках европейского совместного исследовательского проекта DOTFIVE, целью которого является разработка устройств SiGe: C HBT, работающих на частоте 500 ГГц при комнатной температуре.
История Источник:
Материалы предоставлены Межвузовским центром микроэлектроники (IMEC) . Примечание. Содержимое можно редактировать по стилю и длине.
Страница не найдена – MIT Terahertz Integrated Electronics
Джинчен Ван (jinchen @ mit.edu) получил B.Eng. степень в области электронной информационной инженерии от Университета электронных наук и технологий Китая в 2019 году и B.Eng. Степень с отличием первой степени в области электроники и электротехники в Университете Глазго в 2019 году. В настоящее время он работает над докторской степенью. степень с факультетом электротехники и компьютерных наук Массачусетского технологического института. Его исследовательские интересы включают схемы RF / mmW / THz, алгоритмы и системы для создания радиолокационных изображений, беспроводной связи, квантовых вычислений и других новых приложений.Он также был получателем стипендии IEEE для студентов и преддипломных специалистов по теории и технике микроволнового излучения в 2019 году.
Публикации:
1. X. Yi, J. Wang, C. Wang, KE Kolodziej и R. Han, «Внутриполосный полнодуплексный входной каскад в CMOS с частотой 3,4–4,6 ГГц с использованием двунаправленного преобразователя частоты. ”Симпозиум IEEE по радиочастотным интегральным схемам (RFIC) 2020 г., Лос-Анджелес, Калифорния, США, 2020 г., стр. 47-50.
2. X. Yi, C. Wang, X. Chen, J. Wang, J. Grajal и R. Han, «Радар FMCW от 220 до 320 ГГц в 65-нм CMOS с использованием архитектуры частотной гребенки. »В журнале IEEE Journal of Solid-State Circuits.
3. X. Yi, C. Wang, M. Lu, J. Wang, J. Grajal и R. Han, «Гребенчатый радар 4,8 терагерцового диапазона FMCW в 65-нм CMOS с полосой пропускания 100 ГГц», Международная конференция по твердотельным схемам IEEE 2020 г. – (ISSCC), Сан-Франциско, Калифорния, США, 2020, стр. 90-92.
4. К. Ли, Ф. Ю, Дж. Ван, Дж. Хуанг и С. Хе, «Комплексный дельта-сигма-модулятор третьего порядка с произвольными полюсами и размещением нулей», в Electronics Letters, vol. 56, нет. 2, pp. 71-73, 23 01 2020.
5. Дж. Пэн, С. Хе, В. Ши, Т. Яо, Дж. Ву и Дж. Ван, «Адаптивное разделение сигналов для усилителя мощности Доэрти с двумя входами. , ”В IEEE Transactions on Microwave Theory and Techniques, vol.68, нет. 1, pp. 121-131, Jan. 2020.
6. К. Ли, Ф. Ю, Дж. Пенг, Дж. Ван, М. Ф. Хайдер и С. Хе, «Совместное проектирование соответствующих подсетей для реализации широкополосной связи». Симметричный Доэрти с настраиваемой резервной областью », в IEEE Transactions on Circuits and Systems II: Express Briefs, vol. 67, нет. 10, pp. 1730-1734, Oct. 2020.
7. W. Shi, S. He, J. Peng и J. Wang, «Цифровая конфигурация Doherty с двумя входами для сверхширокополосного приложения», в IEEE Transactions on Industrial Electronics, т. 67, нет.9, pp. 7509-7518, Sept. 2020.
8. К. Ли, Ф. Ю, С. Хе, Х. Тан, В. Ши и Дж. Ван, «Высокоэффективный усилитель мощности, использующий гармонику минимальной мощности. Модулятор активной нагрузки »в IEEE Transactions on Circuits and Systems II: Express Briefs, vol. 66, нет. 8, pp. 1371-1375, август 2019 г.
9. К. Ли, Ф. Ю, X. Чжу, Дж. Ван и С. Хе, «Проектирование широкополосного усилителя мощности Доэрти с расширенным диапазоном КПД с использованием асимметричной структуры. ”Азиатско-Тихоокеанская конференция по СВЧ (APMC) 2018 г., Киото, 2018 г., стр.452-454.
10. Дж. Ван, С. Хе, Ф. Ю, В. Ши, Дж. Пэн и К. Ли, «Разработка высокоэффективного усилителя мощности и кольцевого резонаторного фильтра на основе серии непрерывных режимов и даже – Анализ нечетных режимов », в IEEE Transactions on Microwave Theory and Techniques, vol. 66, нет. 6, pp. 2867-2878, июнь 2018.
11. Дж. Ван, С. Хе и Д. Ган, «Четырехдиапазонный BPF 2,4 / 3,5 / 5,2 / 5,8 ГГц с использованием SLR и треугольных петлевых резонаторов», in Электроника Письма, т. 54, нет. 5, pp. 299-301, 8 3 2018.
12. J.Ван, Ю. Гуань, Х. Ю, Н. Ли, С. Ван, К. Шен, З. Дай, Д. Ган, Р. Ян, С. Хе и Г. Чжан, «Прозрачные графеновые микрополосковые фильтры для беспроводной связи. , »В Journal of Physics D: Applied Physics, 50 (34), p.34LT01, 2017.
13. Дж. Ван, Ю. Гуан и С. Хе,« Прозрачный фильтр 5,8 ГГц на основе графена », 2017 IEEE MTT -S Международный симпозиум по микроволновому излучению (IMS), Гонолу, Гавайи, 2017 г., стр. 1653-1655.
Технико-экономическое описание исследования измерительного устройства для непрерывного измерения диаметра и вибрации заготовки в процессе обработки
Данная статья посвящена экономическим и техническим аспектам исследования непрерывного бесконтактного измерения диаметра заготовки. во время производственной операции с использованием правильно подобранного и сконструированного датчика.Для достижения этой главной цели необходимо было выполнить эти частичные цели. Мы разрабатываем и описываем метод точного непрерывного технического измерения диаметра заготовки в процессе обработки. Мы предлагаем принцип непрерывного технического измерения диаметра детали, разрабатываем метод сканирования, основанный на этом принципе, и проверяем разработанное оборудование на конкретном случае технических измерений. В то же время разработка включает расширение использования для непрерывного бесконтактного измерения вибрации заготовки.На основании тестовых измерений был выбран оптический датчик, анализ которого представлен в части статьи. Введение в эту статью дает простой обзор необходимости непрерывного измерения диаметра заготовки. Во второй главе представлено текущее состояние проблемы. Третья глава посвящена теоретическому анализу и описанию практических реализаций решения. Заключение, как и следовало ожидать, включает оценку результатов.
1. Введение
Непрерывные измерения диаметра заготовки основаны главным образом на принципе контактного движения компонента измерительной системы, с помощью которого передается положение поверхности заготовки. Этот метод относительно точен; однако он имеет некоторые подводные камни, такие как износ контактной зоны (увеличивается неточность измерения), необходимость перемещения контактного рычага вперед и назад при замене заготовки, механическая передача вибраций от заготовки к измерительной системе (что приводит к неточности измерения механическое повреждение измерительной системы), а также необходимость очистки зоны контакта от осколков [1–4].
При конкретном измерении диаметра детали этот метод не используется в полной мере по сравнению с его общими возможностями и необходимостью использования высокочувствительной измерительной системы. Это измерение с помощью механической руки находит свое применение в основном в области трехмерного измерения деталей сложной формы или в случае технической диагностики, используемой для поиска и определения дефектных частей машины или другой механической системы, содержащей вращающиеся или скользящие компоненты. В этом случае контактная измерительная система служит для определения отклонения оси, биения, смещения и т. Д.Более подробно эта система описана в публикациях [5–8].
Для достижения конкретного непрерывного измерения диаметра заготовки мы можем сосредоточиться на тех величинах, на которые в наибольшей степени влияет изменение диаметра заготовки. При выборе этих величин упор также делался на другие показатели, влияющие на результат измерения, такие как сложная конструкция механического и электронного устройства, необходимого для обеспечения измерения, простота принципа измерения, энергетическая и экономическая эффективность процесса измерения, а также точность и чувствительность зондирования [9–12].
Приняв во внимание все аспекты и факты, мы остановились на прямом непрерывном измерении диаметра заготовки. Измерение этой величины было выбрано потому, что оно удовлетворяет вышеуказанным требованиям по сравнению с другими возможными величинами [13–18].
Следующие главы этой статьи посвящены измерению изменения размера заготовки, которое затем влияет на другой параметр, являющийся высотой круглого сегмента X в поперечном сечении заготовки (Рисунок 1).Измеряя размер этого параметра, мы можем узнать точный диаметр заготовки. У него также есть несколько других преимуществ. Помимо непрерывного измерения диаметра заготовки, мы сосредоточимся на обработке измеренной величины, ее оценке и применении ее результатов. После проведения соответствующих испытаний оптический датчик оказался успешным по следующим причинам [19–21]: достаточная чувствительность (подходит для измерения изменения размера заготовки), относительно простая и доступная установка и демонтаж датчика в держателе. и станка, простая конструкция датчика как такового, соответствующая его цене, стоимости и времени, эффективное обслуживание, высокая долговечность и постоянство параметров при рекомендованной эксплуатации, незначительное влияние окружающей среды на функциональность и точность измерения [22–29].
В качестве примера результаты мировых исследований в этом направлении могут включать в себя исследования по моделированию рабочего процесса расточной оправки с гасителем колебаний, результаты исследований, представленные в диагностике работы электроприводов и логико-лингвистической модели диагностики электроприводов. с сенсорным сопровождением и результатами исследований при проектировании конструкции и исследования вибраций и теплопередачи горных выработок. В вопросе демпфирования внешних нагрузок на шахтные стойки используются геометрический метод повышения точности деталей машиностроения и тематический анализ эффективности и разработка роботизированного приложения для завинчивания с интегрированной системой визуального контроля для автомобильной промышленности [30–35].
2. Описание устройства для измерения диаметра и вибрации заготовки
На основе хорошо известных превосходных качеств оптических датчиков, подтвержденных измерениями, было разработано непрерывное измерение диаметра заготовки и вибрации. Принцип работы прибора описан на рисунке 1. Он состоит из передатчика, передающего инфракрасный свет, приемника со светочувствительным элементом, держателя и кронштейна с насадкой для инструмента, закрепленной винтами.Регулируемый рычаг крепится к кронштейну и стабилизируется винтом. Регулируемый держатель стабилизируется винтом и размещается с другой стороны кронштейна под заданным углом, в зависимости от горизонтальной плоскости, проходящей через ось заготовки с радиусом R 1 или радиусом R 2 на месте измерения. Измерение выполняется с помощью измерительного устройства, которое позволяет нам напрямую считывать значение радиуса заготовки.
Как показано на рисунке 1, устройство состоит из передатчика, передающего инфракрасный свет, и приемника, работающего по принципу управления мощностью светового луча, который падает на приемную часть, состоящую из светочувствительного элемента.Передатчик и приемник размещаются напротив друг друга на регулируемом металлическом держателе под заданным углом в зависимости от горизонтальной плоскости, проходящей через ось заготовки. Насадка плотно закреплена на кронштейне двумя винтами, на которых устанавливается регулируемый рычаг и при необходимости стабилизируется винтом. С другой стороны регулируемого рычага находится регулируемый держатель с датчиками, который стабилизируется винтом. Луч света передается к светоприемнику под заданным углом в зависимости от горизонтальной плоскости, проходящей через ось заготовки с радиусом R 1 или радиусом R 2 .Однако на определенном участке траектории луч света частично затеняется рабочей поверхностью заготовки, что проявляется в контроле его оптической силы. Затененная часть светового луча X 1 и X 2 зависит от мгновенного размера диаметра заготовки в месте измерения. По этой причине на приемник попадает только часть светового луча. Его размер зависит от размера затененной поверхности заготовки, от диаметра заготовки.Точность и чувствительность измерения зависят от выбранного угла. Угол задается уравнением.
Электрический сигнал от светоприемника обрабатывается путем измерения и оценки с помощью устройства отображения, которое одновременно служит для управления передатчиком светового луча. Инструмент может использоваться для бесконтактного непрерывного измерения диаметра заготовки во время непрерывного изготовления на токарном станке. Чувствительность измерения можно регулировать механически, изменяя величину угла между световым лучом и горизонтальной плоскостью, проходящей через ось заготовки.Точность и чувствительность измерения зависят от размера угла. В качестве источника света используется инфракрасный светодиодный диод. Приемная часть состоит из трех параллельно включенных инфракрасных фототранзисторов. Фототранзисторы расположены близко друг к другу, чтобы обеспечить непрерывное и плавное освещение. Для исключения нежелательных световых лучей перед фототранзисторами размещена апертура.
Размер заштрихованной части X рассчитывается следующим образом. Для угла α между световым лучом и горизонтальной поверхностью, проходящей через ось заготовки, применяется соотношение, показанное на рисунке 2.
Определяется затемненная часть светового луча:
Таким образом,
Процентное затемнение луча:
Отсюда следует, что измеренный радиус R вычисляется:
Другой возможный способ реализации датчика создает рефлексивный оптический датчик, основанный на принципе отражения светового луча от препятствия. Однако величина мощности отраженного света также будет зависеть от шероховатости поверхности детали, и, таким образом, будет создан коэффициент дефекта измерения.Решение этой задачи было разделено на следующие этапы: проектирование чувствительной части устройства, проектирование электрической части устройства, проверка работоспособности устройства и проектирование датчика.
Конструкция размещения датчика основана на предположении, что датчик будет основан на принципе изменения размера мощности светового луча, падающего на приемник, вызванного изменением диаметра заготовки. Также необходимо принять во внимание тот факт, что световой луч должен проходить через зону резания как можно ближе, чтобы он мог немедленно реагировать на изменение размера заготовки, но не слишком близко, потому что отскакивающие осколки могут препятствуют прохождению светового луча.
Чтобы обеспечить точное положение светового луча по направлению к заготовке, должна быть гарантирована возможность точной регулировки. Один из возможных вариантов его конструкции показан на рисунке 3.
Возможность регулировки положения чувствительного луча по отношению к заготовке обеспечивается специальным держателем датчика, содержащим рычаг для регулировки датчика по отношению к . X – ось и Y – ось и угол поворота. Держатель датчика крепится винтами с зубчатыми шайбами для увеличения силы трения.После настройки подходящего положения светового луча винты надежно затягиваются.
2.1. Размещение датчика
При разработке размещения датчика были приняты во внимание различные альтернативы. Однако у этих размещений были различные недостатки, такие как проблема точной настройки перехода светового луча.
Как показано на Рисунке 1, это положение размещения было выбрано, потому что инструмент и световой луч движутся с одинаковой величиной в одном направлении, а датчик регистрирует мгновенное значение диаметра заготовки и вибрации.Воздействие осколка частично устраняется размещением излучателя светового луча с закругленной верхней частью в нижней части устройства и, в то же время, тем, что приемник и передатчик находятся на достаточном удалении от зоны реза.
Большим преимуществом оптического датчика среди других типов датчиков является то, что затенение от внешних электромагнитных и электростатических факторов не требуется, поскольку световой луч устойчив к ним. Еще одно большое преимущество состоит в том, что измерение не зависит от температуры в зоне резки, поскольку приемник и передатчик светового луча находятся на достаточно большом расстоянии от этой зоны.На измерение диаметра заготовки с помощью оптического датчика практически не влияют вибрации заготовки и инструмента. Защита от этих помех обеспечивается RC-фильтром нижних частот, на выходе которого достигается среднее значение измеряемой величины. Переменная составляющая, вызванная этими вибрациями, отфильтровывается из прямой составляющей конденсатором. Затем он управляется двухполупериодным выпрямителем, а его процесс сглаживается выходным конденсатором. Таким образом достигается среднее значение измеренного сигнала на выходе, которое представляет собой величину вибрации детали.Мы можем предотвратить прерывание, вызванное упругой деформацией, поместив датчик в переднюю часть держателя. Чувствительная часть содержит специальный инфракрасный фильтр, пропускающий только инфракрасную часть светового спектра. Таким образом можно исключить прерывание, вызванное проникновением нежелательного света.
3. Устройство электрической части прибора
При изменении диаметра заготовки уменьшается мощность света, падающая на приемную часть датчика.Это изменение преобразуется в изменение электрического напряжения, которое одновременно измеряется и отображается измерительным устройством.
3.1. Возможности измерительного прибора с оптическим датчиком
Измерительный прибор для измерения диаметра заготовки с помощью оптического датчика имеет следующие возможности в процессе измерения: измерение диаметра заготовки с возможностью регулировки диапазона измерения, возможность активного измерения колебания заготовки перед тем, как инструмент начнет резать, чтобы работа была эффективной, возможность подключения устройства к компьютеру и обработки данных вибродиагностики во время измерения, возможность калибровки устройства – устройство портативное и приводится в действие от электричества – и возможность калибровка устройства.
Описание отдельных блоков измерителя. Предлагаемая система содержит следующие блоки: блок, необходимый для измерения диаметра заготовки, и блок, используемый для обработки измеренной величины и достижения требуемой формы и уровня сигнала для оценки диаметра и вибрации заготовки.
Блок необходим для определения радиуса заготовки. По указанным выше причинам мы решили измерять диаметр заготовки бесконтактным оптическим методом непрерывно во время обработки, не снимая заготовку со шпинделя.Для измерения радиуса заготовки использовался точный и чувствительный оптический датчик со светочувствительным элементом, подключенным к электрическому мосту (рис. 4).
Электрический мост был разработан для обеспечения сбалансированного положения и возможности преобразования электрического сопротивления подключенных параллельно фототранзисторов в электрическое напряжение. Номиналы резисторов, помещенных в мост, должны были быть выбраны так, чтобы он не нагружал схему, а выходное напряжение можно было установить в желаемом диапазоне.Выход моста состоит из вольтметра с возможностью выбора диапазона измерения от одной до одной сотой вольта. Блок модели светочувствительного элемента представляет собой три параллельно включенных фототранзистора. Модель состоит из параллельно включенных резисторов, которые постепенно отключаются от цепи с помощью переключателя. Это представляет собой процесс, во время которого принимающая часть постепенно затеняется заготовкой, а электрическое сопротивление фототранзисторов постепенно увеличивается в порядке от одного до трех.Когда эти изменения не выполняются по порядку, произойдет дискретное изменение электрического сопротивления, а также дискретное изменение значения выходного напряжения. Чтобы сгладить процесс от прерывающих импульсов, параллельно фототранзисторам подключен фильтрующий конденсатор. При изменении значений напряжения конденсатор вызывает переходный процесс с задержкой.
Из результатов анализа переходов (рисунок 5) видно, что соединение достигает удовлетворительного изменения напряжения при полном изменении сопротивления.При изменении значения сопротивления светочувствительного элемента с на при включении переключателей с Шага 1 на Шаг 3 электрическое напряжение изменялось с 1,4 В до 1,8 В. Разница составляла 0,4 В. При изменении электрического сопротивления с R 2 до, разница в сопротивлении составляет 0,7 В. Изменение электрического сопротивления от R 3 до вызывает изменение напряжения В 1 на 1,6 В. В 1 является входом напряжение и В 2 – выходное напряжение.Разделение колебаний от диаметра детали показано на рисунке 6. Сигнал получается с фототранзистора. Односторонняя составляющая сигнала V 2 используется для оценки значения диаметра заготовки. Составляющая переменного сигнала V 1 используется для оценки значения вибрации заготовки. Видно, что скорость нарастания напряжения увеличивается с постепенным затемнением приемной части датчика.Это условие очень полезно, потому что на начальном уровне, когда изменения напряжения меньше, диапазон напряжений может быть уменьшен, что позволяет повысить чувствительность датчика даже в этой начальной чувствительной части.
Это обеспечивает достаточную точность датчика во время измерения. Калибровку прибора на ноль проводят калибровочным резистором. RC-фильтр нижних частот, который использовался для уменьшения кратковременных нежелательных сигналов от процесса управления, вызывает задержку перехода величины от одного значения к другому после прихода начального импульса для значения постоянной времени T = R ∙ C , где R обозначает значение сопротивления при зарядке электрического конденсатора C .
3.2. Процедура и условия практических измерений
В качестве модельного устройства использовался специально отрегулированный и прикрепленный микрометрический винт. С помощью этого винта можно добиться точного движения наблюдаемой точки. Датчик был плотно прикреплен к столу. Микрометрический винт, установленный перпендикулярно лучу датчика, заменял заготовку с изменяющимся диаметром. С помощью рабочего винта подвижный наконечник, заменяющий заготовку, перемещается к балке, так что заготовка в определенной степени затемняется.Эта точка устанавливается как начальная, и значения микрометрического винта и вольтметра вычитаются. Затем подвижный наконечник, создающий тень, перемещается на первое измеренное значение Δ X и вычитается значение с микрометрического винта и вольтметра. Затем подвижный наконечник, создающий тень, отодвигается. Во втором измерении он возвращается в то же положение, что и в предыдущем измерении. Измерение повторяется 10 раз с тем же положением подвижного наконечника, создавая тень.Измерения проводятся при 10 различных положениях наконечника, и результаты оцениваются.
3.3. Определение диапазона точности измерения и проверка работы датчика
Постепенно напряжение измерялось в различных положениях наконечника, создавая тень. Результаты представлены на рисунке 7. Графическая зависимость конкретных характеристических значений и их взаимное сравнение показано на диаграммах на рисунках 7 и 8.
Из измеренных значений видно, что зависимость измеряемого напряжения от положения кончика, создающего тень, на определенных интервалах почти линейный.Результатом является графическая диаграмма перехода на рисунке 8. Кроме того, процесс разделения на части можно линеаризовать и использовать для измерения диапазонов переключения отображаемых элементов.
4. Практическая проверка прибора
При практической проверке оптического датчика для измерения диаметра и вибрации были получены хорошие результаты. Оптический датчик был установлен на токарном станке, производство шло. Заготовка (рис. 9) имела градуированные диаметры. Датчик был протестирован для каждого диаметра.Результат измерения сравнивался с фактическим. Расчетная выгода в производстве составляет 15%. Проведена практическая проверка работоспособности прибора для измерения диаметра. Форма испытуемого образца (материал 100CrMnSi6-4) показана на рисунке 9. Часовая производительность при классических средних измерениях составила 11 штук в час. Количество измерений в час составляло 132. Время, необходимое для одного классического среднего измерения, составляло 8 секунд, 17,6 минут в час.Благодаря автоматическому измерению диаметра это время экономится. Благодаря использованию автоматического измерения диаметра шаги, необходимые для измерения классическим способом, будут сокращены. Сэкономленное время означает более низкие производственные затраты и более эффективное производство.
4.1. Преимущества для практики
Повышение эффективности контроля диаметра заготовки непосредственно во время токарной обработки экономит время, необходимое для выполнения контрольных измерений размера детали во время обработки для получения информации о точности обработки.Избегайте изготовления недостаточно точных деталей из-за нежелательных вибраций детали и инструмента во время токарной обработки. Более высокая эффективность процесса управления обработкой достигается за счет возможности применения механизма обратной связи для остановки станка в случае превышения предельного значения вибрации или износа инструмента. Количество инспекторов сокращается благодаря постоянному контролю за процессом токарной обработки с возможностью компьютерной обработки данных, что позволяет экономить время, необходимое для выполнения контрольных измерений размера детали во время обработки для обнаружения износа клина инструмента.Повышенная эффективность управления процессами обработки за счет возможности концентрации данных с нескольких станков на одном компьютере, более высокая эффективность в процессе реализации компенсации износа клина режущего инструмента за счет возможности применения автоматической коррекции, выполняемой вспомогательное скользящее устройство, управляемое элементом управления, более высокая эффективность управления процессом обработки за счет возможности реализации управления несколькими станками одновременно с помощью компьютера, путем применения соответствующего программного обеспечения, а также более высокая эффективность удаленного мониторинга и контроль процесса обработки за счет возможности передачи данных по электронной сети.Есть возможность архивирования данных, полученных в процессе обработки.
4.2. Преимущества для теории
Представлено теоретическое описание следующего: математическая модель эксцентрично вращающейся детали с точки зрения обработки; оптический датчик, работающий с экранирующим экраном, по принципу действия и возможности применения в области механической обработки; практическое применение биполярного транзистора, работающего в области наибольшего нарастания тока; математическая модель процесса износа клина режущего инструмента с применением в области моделирования; математическая модель процесса коррекции износа режущего инструмента с применением в среде моделирования; пример применения функции вероятности R ( t ) в процессе обработки и практического применения микроконтроллера в качестве аналого-цифрового преобразователя.
4.3. Преимущества для педагогического процесса
Преимущества педагогического процесса заключаются в демонстрации технической конструкции и измерений при принятии учебной программы; выполнение измерений, используемых для разработки заданий; выполнение мерок, используемых при подготовке выпускных бакалаврских и магистерских диссертаций; и образцы измерений для проверки функциональности и принципа измерения.
5. Заключение
Использование оптических датчиков при токарной обработке имеет ряд преимуществ, особенно благодаря таким свойствам, как бесконтактность, устойчивость к большинству помех и достижение высокой точности.Эта работа решила непрерывное измерение диаметра заготовки в процессе обработки. Этот принцип прошел практическую и теоретическую проверку и отвечает всем требованиям для практического применения. Сопутствующее применение этого датчика было показано для измерения вибрации заготовки перед фактическим снятием ножа, так что обработка не является неэффективной. Измерение вибрации перед снятием ножа позволит определить правильность прижима заготовки к шпинделю, изгиб заготовки или аномалию в геометрии заготовки.
При сравнении этого метода с другими методами можно начать с разных точек зрения. Точность метода, основанного на измерении вибрации, в значительной степени зависит от точности настройки системы, образованной инструментом и заготовкой. На точность метода, основанного на измерении силы, действующей на инструмент, или температуры вблизи зоны резания, в основном влияет твердость технического материала, а также настройки системы, образованной инструментом и заготовкой, или параметрами резания. .В случае измерения износа клина режущего инструмента это процесс с очень небольшой динамикой в течение относительно большого интервала времени. По этой причине не очень важно иметь дело со сравнением методов измерения с точки зрения возможностей зондирования с наименьшей возможной задержкой. При проверке функции датчика в процессе обработки для данного типа держателя датчика возникли трудности с исходящей микросхемой большего размера. Следовательно, необходимо спроектировать держатель минимальных размеров в месте расположения заготовки с максимально возможным удалением от заготовки.
Измерительный прибор оснащен аналого-цифровым преобразователем, созданным из программируемого микроконтроллера Arduino. Микроконтроллер имеет модульную конструкцию, имеет входы и выходы и может взаимодействовать с другими устройствами того же, но и другого типа. Аналого-цифровой преобразователь подключается к компьютеру через разъем USB, но программирование происходит на компьютере через смоделированный последовательный интерфейс. В микроконтроллер запрограммирована функция преобразования, которая позволяет напрямую отображать значение требуемого количества и в требуемых единицах.Визуально отображаемое значение обновляется с регулируемой частотой.
Исследуемый прибор имеет широкое практическое применение. Его применение возможно в обрабатывающей промышленности в качестве диагностического прибора для моделирования рабочего процесса буровой оправки с гасителем колебаний, а также в качестве прибора для диагностики электроприводов и логико-лингвистической модели диагностики электроприводов с опорой на датчики.


